Ⅰ. 서 론
밀리미터파 온-보드 측정을 위한 플립-칩 본딩 플립-칩 공정을 이용한 패키지(package)는 고밀도 입출력 인터커넥션이 가능하여, 저비용으로 여러 시스템(system)을 하나의 패키지로 만드는 SiP(system in package) 구현을 위해 많은 연구가 이루어져 왔다[1]. 그뿐만 아니라, 솔더 범프를 이용하는 플립-칩 본딩은 와이어 본딩에 비해 물리적 연결되는 길이를 크게 줄일 수 있어, 와이어 인덕턴스를 줄일 수 있는 장점이 있다. 전송선로의 임피던스가 회로 성능에 큰 영향을 미치는 mm-Wave 시스템에서 집적회로(integrated circuit)와 인쇄 회로 기판(PCB)을 전기적으로 연결할 때 신호 무결성을 유지하는 것은 매우 중요하다[2],[3]. 이러한 이유로, PCB와 IC 사이의 인터커넥션에서 신호손실을 최소화하기 위해 솔더 범프의 크기를 줄이려는 연구가 이루어져 왔다[4].
본 연구에서는, 65 μm 지름의 솔더 범프를 이용하여 PCB와 IC를 전기적으로 연결하고, 신호 전달 특성을 확인하였다. 결과적으로, DC부터 43.5 GHz까지 15 dB보다 좋은 반사 손실을 갖는 신호 전달 특성을 확인하였다.
Ⅱ. 플립-칩 Transition 설계
플립-칩 transition 설계를 위해 먼저 PCB와 IC 50-Ω 전송선로를 설계하였다. IC에서 설계한 전송선로의 경우, GCPW(grounded coplanar waveguide) 구조로 제작되었으며, signal line의 너비는 6 μm, signal line과 side ground의 간격은 4 μm, 그리고 bottom ground와 signal line 사이의 높이는 8.7 μm로 제작하여 집적회로상에서 최적의 50-Ω 특성을 갖는 전송선로를 제작하였다. PCB 설계의 경우 두께가 101 μm인 Ro4350B(εr=3.66, tanδ=0.0037) 기판을 이용하여 제작하였다. HFSS EM simulation으로 검증하고 제작한 PCB 50-Ω 전송선로의 경우 signal line의 너비는 160 μm, signal line과 side ground 사이의 간격 100 μm 그리고 signal line과 bottom ground 사이의 간격은 101 μm일 때 최적의 50-Ω 전송선로 특성을 보였다. 결과적으로, Ka-band 전 대역에 걸쳐서 50-Ω 특성을 유지하면서, 집적회로로의 transition을 고려하여, PCB상에서 signal line 너비가 최소가 되도록 전송선로를 제작하였다. PCB와 IC에 제작된 50-Ω 전송선로의 특성을 파악한 후 플립-칩 본딩 공정으로 PCB와 IC의 사이의 transition을 만들었다. 플립-칩 transition은 그림 1과 같이 PCB 위에 IC chip을 뒤집어 올리고, IC pad와 PCB pad의 연결은 솔더 범프를 이용하여 본딩하였다.
DC부터 Ka-band 주파수 대역까지 측정하기 위해 2.92 mm 커넥터를 사용하였고, 커넥터로부터 PCB로 feeding 되는 부분에서의 신호손실을 최소화하기 위해 테이퍼링(tapering)을 통해 불연속선(discontinuity)이 최소화되도록 하였다.
Full wave 시뮬레이션은 HFSS(high frequency structure simulator) EM 시뮬레이션 tool을 이용하여 진행하였고, 그림 2와 같이 커넥터와 PCB 그리고 IC chip을 포함하여 최종 EM 시뮬레이션을 진행하였다.
Ⅲ. 측정 및 시뮬레이션 결과
제작된 기판의 S-parameter 측정은 Anritsu사의 MS46524B 네트워크 애널라이저를 이용하여 진행하였다. 또한, 열 개 이상의 측정을 통해 측정 결과의 신뢰성을 확인하였다. 그림 3은 18.23 mm의 길이의 PCB 50-Ω 전송선로의 EM 시뮬레이션 구조와 제작 사진이다. 그림 4는 설계한 18.23 mm PCB 전송선로의 시뮬레이션값과 측정값을 비교한 그래프이다. 측정 결과, DC−43.5 GHz에 걸쳐서 15 dB 이하의 반사손실이 측정되었다. 또한, 28 GHz에서 삽입 손실은 2.5 dB로 측정되었으며, 1,901°의 위상 지연이 측정되었다.
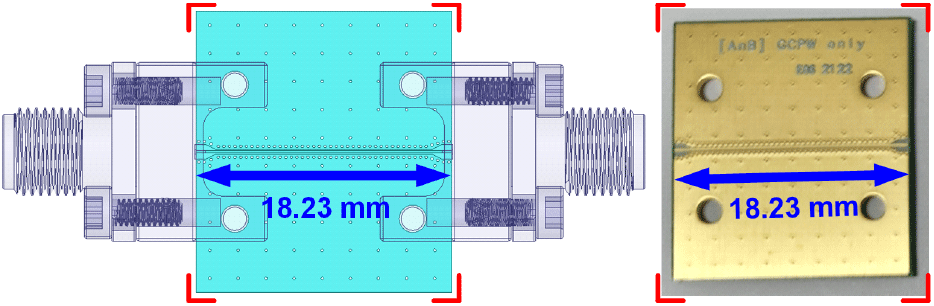
그림 5는 집적회로로 제작된 50-Ω 전송선로 사진이다. 그림 6은 설계한 1,760 μm의 집적회로 전송선로의 시뮬레이션값과 측정값을 비교한 그래프이다. 측정 결과, DC부터 43.5 GHz까지 10 dB 이하의 반사손실이 측정되었다. 또한, 28 GHz에서 삽입 손실은 1.37 dB로 측정되었으며, 77°의 위상 지연이 측정되었다.
그림 2의 구조의 EM 시뮬레이션 결과가 그림 8에 점선 그래프로 나타내었다. IC 전송선로를 PCB 전송선로에 플립-칩 본딩하여 제작한 board 사진이 그림 7에 나와 있다. 그림 7의 회로를 측정한 결과를 그림 8에 실선 그래프로 나타내었으며, 측정 결과 DC부터 40 GHz까지 15 dB 이하의 반사손실이 측정되었다. 또한, 28 GHz에서 3.82 dB의 삽입 손실이 측정되었으며, 2,024°의 위상지연이 측정되었다.
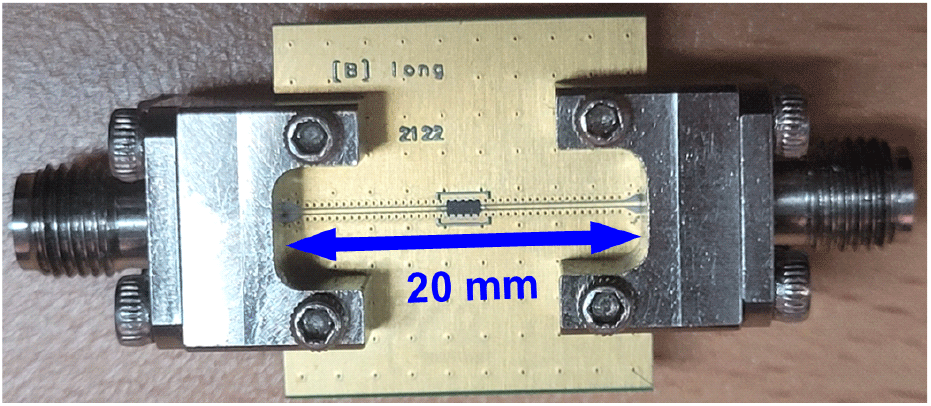
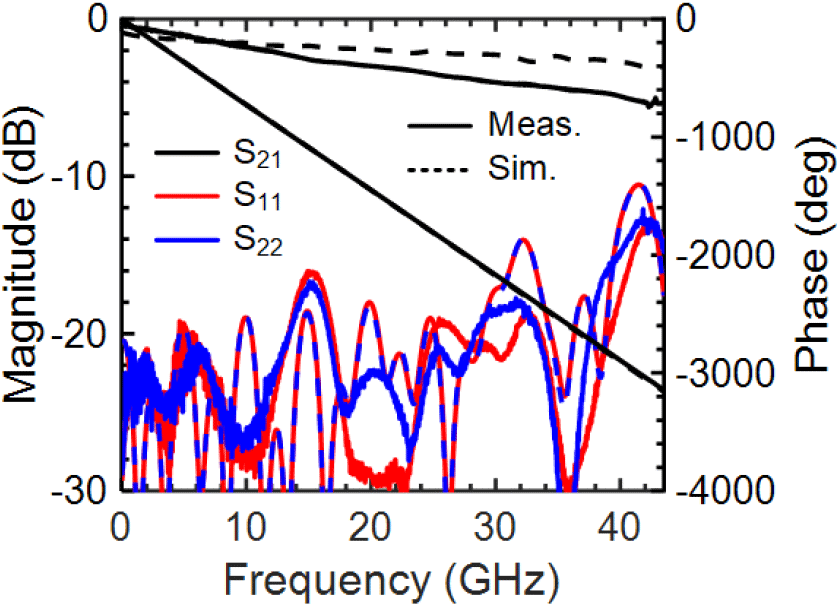
28 nm CMOS 공정에서 GCPW 구조의 50-Ω 전송선로를 설계하고, CoB(chip-on-board) 패키지를 위한 PCB board에서 GCPW 50-Ω 전송선로를 설계하여, 플립-칩 본딩으로 전기적으로 연결하여 CoB를 완성하였고, 2.92 mm 커넥터를 이용하여 온-보드 mm-Wave RFIC 측정을 진행하여 신호 전달 특성을 VNA(vector network analyzer)를 이용한 S-parameter 측정으로 확인한 결과, DC부터 43.5 GHz까지 −15 dB 이하의 임피던스 정합 정도를 보장함을 확인하였다. 또한, PCB와 집적회로의 삽입 손실 단일측정 결과가 각각 2.5 dB와 1.37 dB로 측정되었으므로, 플립-칩 본딩 측정 보드에 제작된 50-Ω 전송선로의 삽입 손실은 3.87 dB로 계산할 수 있다. 그리고, 2 0mm의 길이로 제작된 플립-칩 본딩 보드에서 삽입 손실이 3.81 dB로 측정되었다. 결과적으로, 플립-칩 범프 transition으로 인한 신호손실은 측정 환경에서 발생하는 측정 오차 범위 이내로 작음을 확인할 수 있었다.
결과적으로 지름 65 μm 솔더 범프를 이용하여 플립-칩 본딩으로 PCB와 IC transition을 제작할 때, 범프 transition에 의한 신호손실은 본 실험 환경의 측정 오차 이내로 매우 작음을 확인할 수 있었고, DC−43.5 GHz까지 −15 dB 이하의 반사손실이 있음을 측정을 통해 확인하였다. PCB와 집적회로의 위상 지연 단일측정 결과가 각각 1,901°와 77°로 측정되었고, 플립-칩 본딩 보드에서의 위상 지연은 2,024°로 측정되었다. 결과적으로 PCB와 IC 위상 지연 단일측정결과와 플립-칩 본딩 보드 위상 지연 측정 결과에서 차이인 46°이므로, 범프를 통한 신호 전달에서 23°의 위상 지연이 있음을 알 수 있었다.
Ⅳ. 결 론
본 연구를 통해 IC로 설계된 mm-Wave 회로를 온-보드로 DC−43.5GHz까지 측정할 수 있는 설계 방법에 대해 제안하였다. 플립-칩 본딩으로 집적회로 전송선로를 실장 한 PCB 회로를 on-board 측정한 결과, DC부터 43.5 GHz까지 반사손실이 15 dB 이하였고, 삽입 손실의 경우 28 GHz에서 3.82 dB로 측정되었다. 또한, 플립-칩 범프 인터커넥션에 의한 삽입 손실의 경우, 측정 환경에서의 측정 오차 범위 이내로 매우 작음을 측정을 통해 확인했다. 결과적으로, 플립-칩 본딩을 이용한 온-보드 측정을 통해 DC−43.5 GHz 주파수에서 개발된, 복잡한 mm-Wave 집적회로를, 정교한 컨트롤이 필요한 프로브 스테이션 없이, 쉽고 정확하게 측정할 수 있음을 실험을 통해 확인하였다.