Ⅰ. 서 론
테라헤르츠 대역은 그 범위가 여러 가지로 제시되고 있으나, 가장 널리 사용되는 기준으로는 일반적으로 100 GHz~10 THz의 범위를 일컫는다. 이 대역은 전통적인 전자공학의 응용 주파수 범위와 광학의 응용 주파수 범위 사이에 위치하고 있으며, 오랜 기간에 걸쳐 높은 수준의 이론적 연구와 기술적 진전이 있었던 두 전통 분야 사이의 스펙트럼에 위치하여 상대적으로 연구 및 응용이 미진하였던 면이 있다. 이러한 이유로 이 대역은 테라헤르츠 갭(THz gap)으로 불리기도 한다. 이 대역의 활용이 상대적으로 낮았던 이유로서는 테라헤르츠 대역에서 동작하는 소자의 부재를 가장 큰 이유로 들 수 있겠다. 전자소자의 경우, 주파수가 높아질수록 출력 전력을 비롯한 대부분의 특성이 열화되고, 광소자의 경우, 주파수가 낮아질수록 일반적으로 이러한 특성의 열화가 일어난다. 양쪽 소자 어느 쪽에 기반하여서도 좋은 특성을 얻기 어려운 주파수 대역이 바로 테라헤르츠 대역이다.
그러나, 최근 들어 소자의 전반적인 특성의 향상으로 테라헤르츠 대역에서도 적정 수준 이상의 소자 성능을 얻는 것이 가능해졌으며, 이에 따라 이 대역의 장점을 활용한 응용 연구도 활발해지고 있다. 테라헤르츠 대역을 활용한 주목할 응용으로서는 분광, 이미징, 광대역 통신, 레이다 등을 들 수 있겠다. 테라헤르츠 분광의 경우, 테라헤르츠 대역에 존재하는 고유 분광 특성에 대한 분석 및 활용이 가능해지고, 테라헤르츠 이미징의 경우, 테라헤르츠파가 가지는 고유한 투과 및 반사 특성을 활용한 이미지 획득이 가능하다. 테라헤르츠 통신의 경우, 기존 무선 통신에 비해 훨씬 넓어진 대역폭에 기반한 초고속 통신 시스템의 구현이 가능해지고, 테라헤르츠 레이다의 경우, 기존 대비 향상된 분해능을 제공할 수 있다.
그러나, 이러한 특성을 살린 테라헤르츠 시스템을 구현하기 위해서는 아직 극복해야 할 기술적 난제가 곳곳에 산재해 있다. 그 중에서도 가장 핵심적인 측면이 고성능 테라헤르츠 신호원의 개발이라 할 수 있으며, 이에 대한 시급한 기술적 진보가 요구되고 있다. 응용에 따라 다소 차이가 있을 수 있지만, 대부분의 테라헤르츠 시스템이 높은 출력과 함께 낮은 위상 잡음을 가진 안정적인 신호 발생을 필요로 한다. 테라헤르츠 신호 발생을 위해서는 여러 가지 접근 방식이 고려될 수 있는데, 그 다양한 방식이 그림 1 에 개념적으로 도시되어 있다[1]. 일단 광소자 기반 방식과 전자소자 기반 방식으로 나누어 볼 수 있으며, 전자소자 방식은 다시 진공소자 방식과 고체소자 방식으로 분류될 수 있다. 고체소자 방식은 실제로는 대부분 반도체에 기반하여 구현이 되는데, 다시 다이오드 기반 방식과 트랜지스터 회로 기반 방식으로 구분하여 볼 수 있다. 본 고에서는 이 중에서 반도체 전자소자 기반 방식 테라헤르츠 신호원에 대해 동작 원리를 살펴보고, 이들 방식, 특히 트랜지스터 회로에 기반한 방식의 최근 실제 구현 사례를 소개하도록 한다.
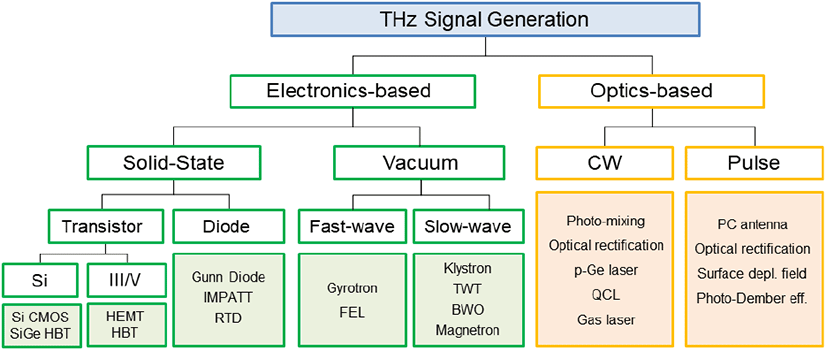
Ⅱ. 다이오드 기반 테라헤르츠 신호원
다이오드 기반 고주파 신호원으로 널리 사용되는 대표적인 소자로서 Gunn diode, IMPATT(IMPAct ionization transit time) diode, RTD(resonant tunneling diode) 등을 들 수 있는데, 이들 소자들은 소자 구조의 최적화를 통해 그 동작 주파수를 테라헤르츠 대역까지 확장할 수 있다. 이들 소자의 신호발생 원리는 기본적으로 부성저항의 발생에 있다. 그림 2에서 보이는 바와 같이 전류-전압 특성에서 기울기가 부분적으로 음의 값을 가지게 되면 소자 내 발진이 일어나게 된다. 이러한 발진으로부터 연속파 (CW) 신호를 발생시킬 수 있는데, 이들 각 소자는 부성저항을 유도하는 방식에서 차이가 있다. 이에 각 소자별로 부성저항을 발생하는 방식에 대해 알아보고, 그 특성에 대해 살펴보도록 한다.

Gunn diode 동작 원리를 파악하기 위해서는 약간의 반도체 물성에 대한 소개가 필요하다. 반도체를 포함한 고체소자 내에서의 전송자(전자 혹은 양공)의 특성을 결정하는 것이 흔히 E-k 다이어그램으로 나타내어지는 에너지 밴드 구조이다. GaAs나 InP를 포함한 많은 III-V 족 화합물 반도체의 경우, 공통적으로 다소 특이한 E-k 관계를 보여주는데, 이는 그림 3에 보이는 바와 같이 main valley(G valley) 근처에 satellite valley가 형성되어 있다는 점이다. 이들 satellite valley는 일반적으로 main valley에 비해 완만한 곡률을 보여주고 있는데, 이는 satellite valley 에 위치한 전자들이 main valley에 위치한 전자들에 비해 상대적으로 낮은 전송도(mobility)를 보임을 의미한다.

이러한 E-k 관계를 보여주는 반도체의 양단에 전압을 인가하고 전류를 관찰한다고 가정해 보자. 전압의 크기가 작을 때에는 전자의 대부분이 main valley에 위치하고 있으며, 따라서 평균적으로 높은 전송도를 보여주는 상태를 유지한다. 하지만 전압의 크기가 증가하여 소자 내의 전기장의 세기가 일정 값 이상을 나타내게 되는 경우, 다수의 전자가 에너지를 얻어 satellite valley로 전이하게 된다. 그 결과로서 소자 내 평균적인 전자 전송도의 일시적 감소 현상이 일어나게 되며, 이를 외부에서 관찰을 하게 되는 경우 소자에 흐르는 전류의 감소로 나타나게 된다. 즉 소자 양단에 일정 수준 이상의 전압을 인가하는 경우, 특정 구간에서 전류가 전압의 증가에 따라 감소하는 특이 특성을 보여주게 되며, 결과적으로 소자 양단에 부성 저항이 유도된다. 이때 소자의 양단에 적절한 공진 회로가 연결되어 있으면 발진기가 구성이 되어 소자 내에서 발진이 유도되며, 그 주파수는 연결된 공진 회로의 공진 주파수에 의해 결정이 된다[2],[3]. 이러한 발진 현상을 통해 신호발생이 이루어지게 되며, 발진기 구조의 최적화를 통해 테라헤르츠 대역에 이르는 신호 발생이 가능하게 된다.
이러한 원리에 바탕을 둔 Gunn diode는 지난 수십년간 유용한 고주파 신호 발생기로 널리 활용이 되어 왔으며, 많은 상용 제품도 나와 있다. Gunn diode의 발진 주파수는 꾸준하게 향상을 하여 최근에는 수백 GHz 대역에 이르게 되었으며, 따라서 테라헤르츠 대역의 신호원으로서의 역할이 가능하게 되었다[4]. 주로 InP나 GaAs에 기반하여 개발이 이루어지고 있으며, 최근 들어 약 500 GHz 에 근접하는 동작까지 보고된 바 있다. 앞서 언급된 바와 같이 고주파 신호원에 있어서 주파수 향상과 함께 또 하나의 중요한 요소가 신호 출력 수준의 향상이다. 지금까지 보고된 결과에 따르면 Gunn diode는 100 GHz~200 GHz 대역 기준 약 20 dBm에 이르는 출력 전력을 보여주고 있다. 그림 4에 100 GHz 이상 동작하는 Gunn diode의 특성이 정리되어 있다[1].
IMPATT diode의 동작원리의 이해는 p-n 접합 다이오드의 avalanche breakdown 현상의 이해에서 출발한다. 반도체소자 기초 이론에서 설명되는 바와 같이, p-n 다이오드에 역방향 전압을 인가하면 전류가 거의 흐르지 않다가 일정 값(breakdown 전압) 이상의 역방향 전압이 가해지면 갑자기 큰 역방향 전류가 흐르게 된다. 많은 경우에 있어 avalanche breakdown 현상이 이러한 급격한 전류 발생의 원인이 된다. 반도체 내에서 이동하는 전자가 격자를 구성하는 원자나 불순물과 충돌하면서 잃은 에너지에 의해 전자-양공 쌍이 만들어지는 현상을 impact ionization 라 하는데, 이러한 impact ionization이 연속적으로 발생하여 짧은 시간내에 다량의 전자와 양공이 만들어지는 현상이 avalanche breakdown이다. 이렇게 생성된 다량의 전자와 양공이 역방향 전압에 의해 이동하면서 역방향 breakdown가 형성된다. 이때 중요한 점은 breakdown 전류가 형성되기 위해서는 연쇄적인 impact ionization이 필요하게 되며, 따라서 유한한 지연시간(delay time)이 소요된다는 점이다. 이에 더불어, 생성된 전자와 양공이 소자 양단의 전극까지 이동하여 외부 전류로서 관찰되기까지에 추가적인 지연시간이 소요된다. 즉 외부에서 일정 값 이상의 역방향 전압을 가한 후 전류가 실제로 관찰될 때까지는 두 가지 원인에 의해 어느 정도의 지연시간을 소요하게 된다.
이제 좀 더 실질적인 상황을 가정하여 보자. p-n 다이오드 양단에 breakdown 전압보다 약간 작은 값의 DC 전압을 인가하고, 여기에 추가하여 사인 파형의 AC 전압 신호가 더해지는 상황을 가정해 보자. 이 경우에는 사인 파형의 양의 주기에서 전체 전압이 breakdown 전압을 상회할 경우에만 avalanche breakdown이 일어날 것이고, 따라서 소자 외부에서 측정되는 전류는 일정 간격을 두고 주기적으로 관찰될 것이다. 이때 앞서 설명된 지연시간 때문에, 측정된 주기적 전류 신호는 인가된 전압 신호에 비해 일정 값의 위상 지연을 보일 것이다. 이 경우에 만약 우리가 지연시간을 적절히 조정할 수 있다면 전류 신호와 전압 신호의 위상이 정확히 반대가 되도록 (즉 위상차가 180°가 되도록) 조율하는 것이 가능할 것이다. 이런 상황에서는 전압의 증가 주기가 전류의 감소 주기에 해당하게 되므로, 소신호적 측면에서 부성저항을 얻게 되며, 따라서 이러한 IMPATT diode 구조는 발진기로서 활용이 가능하다[5],[6]. 실제 지연시간의 조정은 p-n 접합 부위와 전극 간의 거리의 조정을 통해 얻어질 수 있으며, 많은 경우에 있어서 원하는 지연시간을 얻기 위해 전자의 이동 거리를 의도적으로 증가시킨 p-i-n 다이오드 구조를 사용한다. 일반적인 IMPATT diode 구조와 전류-전압의 시간 축 상에서의 관계가 그림 5에 나타나 있다[1].
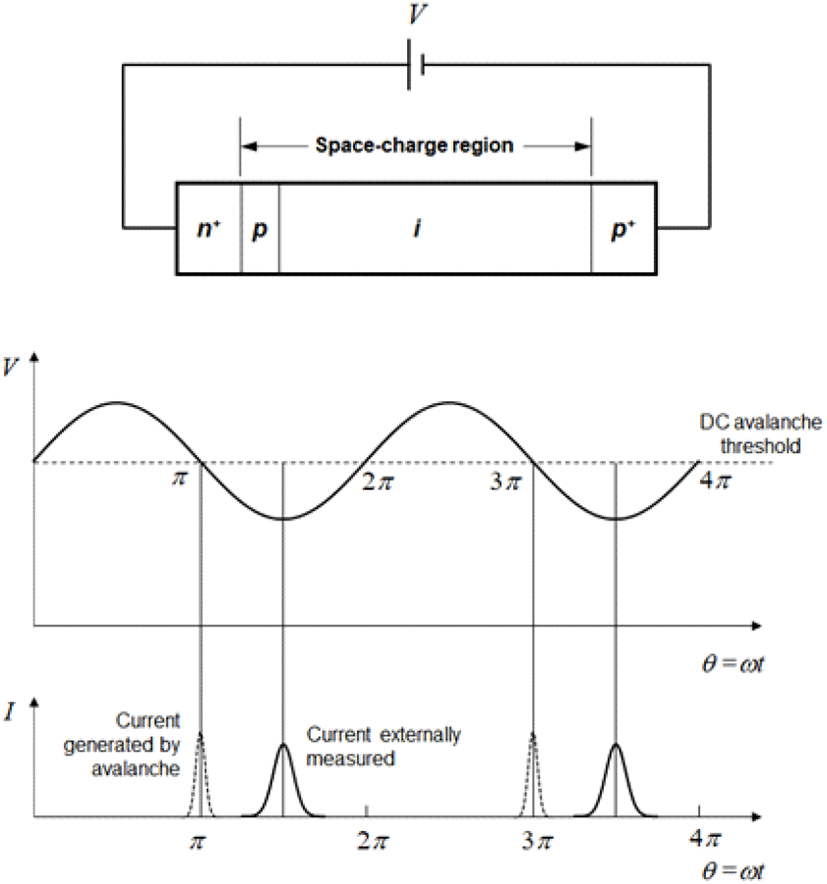
IMPATT diode도 고주파 신호발생기로 오랜 기간 활용되어 왔으며, 구조의 최적화를 통해 주파수를 향상시키려는 노력이 있어 왔다[7]. 그 결과, 그림 6에서 보여주는 바와 같이 약 400 GHz에 이르는 발진 주파수까지 보고된 바 있다[1]. 100 GHz~200 GHz 대역 기준으로는 20 dBm을 넘어서는 출력 전력이 보고되고 있으며, Gunn diode와 비교할 때 유사하거나 약간 높은 수준의 출력 전력 값을 보여준다. 한가지 주목할 점은 Gunn diode와는 달리 Si에 기반하여서도 발진을 얻을 수 있으며, 실제로 그림 6에서 보여 주는 바와 같이 GaAs뿐 아니라, Si 기반 IMPATT diode도 다수 보고되고 있다.
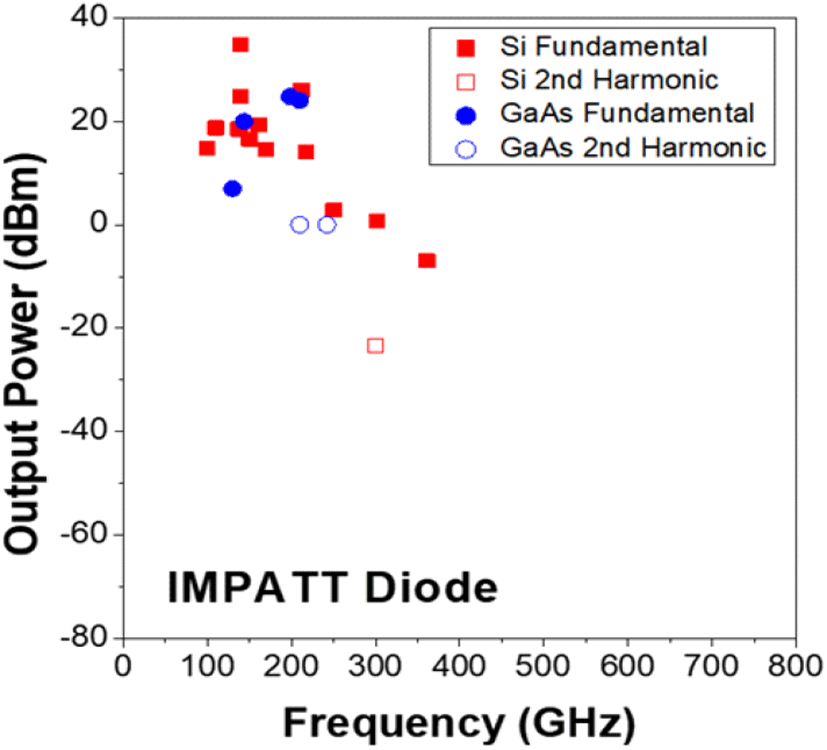
RTD의 동작원리를 이해하기 위해서는 약간의 양자역학 배경 지식, 그 중에서도 터널링 현상에 대한 이해가 필요하다. 양자역학의 기본 개념은 전자가 미세한 구조 내에서 연속적이 아닌 양자화된 에너지 값을 가진다는 사실이다. 가장 간단한 구조로서 전위 양자 우물 속에 갇힌 전자를 가정할 수 있으며, 이 경우, 전자는 특정한 에너지 값들만 가질 수 있는 상태로 양자 우물 속에 머물러 있다. 이때 만약 전위장벽이 전자가 가지고 있는 에너지 보다 훨씬 높더라도 그 장벽의 폭이 매우 작다면 전자는 양자 우물을 탈출할 수 있음이 이론적으로 증명 가능한데 이 현상을 터널링이라 부른다.
이제 잠깐 우리의 관심을 이동하여, 반도체의 전도대 (conduction band)를 생각해 보자. 만약 밴드갭이 작은 반도체로 구성된 영역이 밴드갭이 큰 반도체의 두 영역 사이에 끼어 있다고 가정한다면, 앞서 기술된 바와 같은 양자 우물이 반도체 전도대에 형성되게 된다. 이때 작은 밴드갭 반도체의 전도대 내에 위치한 전자는 양자화된 에너지 값을 가진 상태에서 양자 우물 내에 갇혀 있게 된다. 그러나 이를 둘러싼 큰 밴드갭 반도체 영역이 매우 얇다고 가정한다면, 앞서 설명된 바와 같이 전자가 터널링에 의해 양자 우물을 빠져나오는 것이 가능하며, 이러한 터널링은 특히 양자 우물 내의 에너지 준위가 우물 장벽 바깥 쪽의 에너지 준위와 정렬이 될 때 더 큰 확률로 발생하게 된다. 이와 같이 에너지 준위의 정렬에 의해 발생하는 터널링을 공진 터널링(resonant tunneling)이라 하며, 이 현상을 이용한 다이오드가 resonant tunneling diode, 즉 RTD이다[8],[9].
실제로 RTD의 전도대 에너지 다이어그램은 그림 7에 보이는 바와 같으며, 작은 밴드갭 반도체 내에 전자의 양자화된 에너지 준위가 보여지고 있다. 이 반도체 양단에 전압을 인가하면, 양자우물 내의 에너지 준위와 양자우물 밖의 페르미 레벨 간의 상대적인 위치가 변화하게 되며, 특정 전압 값에서 에너지 수준의 정렬이 이루어진다. 이 경우 공진 터널링에 의해 비교적 큰 값의 전류가 흐르게 된다. 이 상태에서 만약 전압을 더 증가시킨다면 에너지 수준의 정렬이 무너지게 되어 전류 값이 감소하게 되며, 결과적으로 이 영역에서 RTD는 부성저항을 보이게 된다. 따라서 이를 활용한다면 발진을 얻을 수 있다.
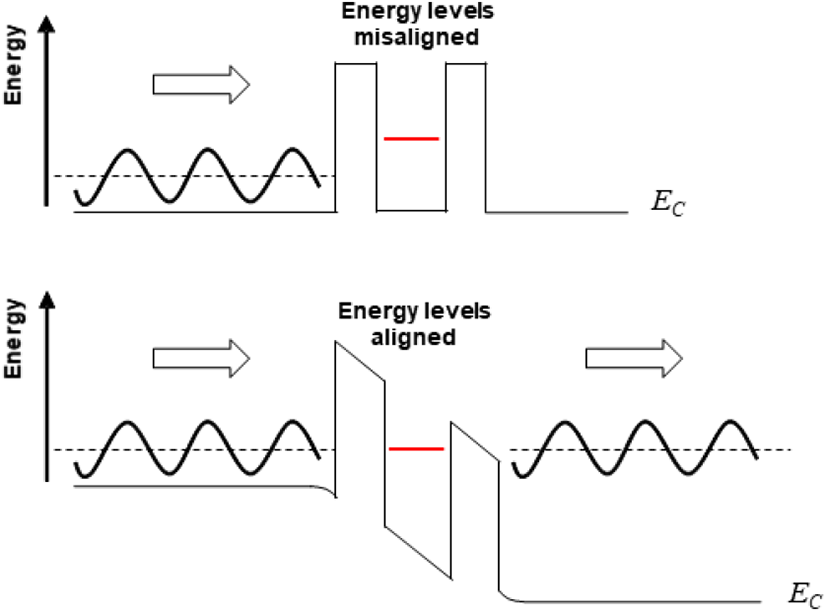
보고된 RTD의 특성이 그림 8에 나타나 있다[1]. 앞서의 두 다이오드 신호원에 비해 가장 뚜렷하게 보여지는 RTD 만의 특성은 훨씬 높은 발진 주파수를 얻을 수 있다는 점이다. 보고되는 발진 주파수는 계속해서 증가하고 있으며, 최근에는 그림에서 보이는 바와 같이 2 THz에 근접하는 발진주파수까지 보고된 바 있다[10]. 단지 전반적으로 RTD의 출력 전력은 상대적으로 낮은 값을 보이고 있어 100 GHz~200 GHz 대역에서 0 dBm보다 낮은 값이 보여지고 있다. 그러나, 주파수 증가에 따른 출력 전력 감소는 상대적으로 완만하여, 1 THz 대역에서도 −10 dBm 보다 높은 값이 유지되는 경향이 있다.
Ⅲ. 트랜지스터 회로 기반 테라헤르츠 신호원
다이오드 기반 발진기에 비해 트랜지스터 회로에 기반한 발진기는 발진 주파수의 증가에 어느 정도 한계가 있어 왔다. 이는 기본적으로 트랜지스터 회로 기반 발진 동작이 1보다 큰 트랜지스터 이득을 필요로 하기 때문이며, 이는 트랜지스터의 동작속도에 의해 제한이 된다. 그러나, 최근 들어 반도체 공정 기술의 향상에 힘입어 소자의 동작 속도가 큰 폭으로 향상이 되었으며, 이는 이러한 소자에 기반한 발진기 회로의 발진 주파수의 증가로 이어져 왔다. 트랜지스터 회로 기반 발진기는 앞서 살펴본 특수 다이오드 구조와는 달리, 일반적인 표준 트랜지스터 구조를 활용하기 때문에 범용 반도체 공정에 기반하여 구현할 수 있다는 장점이 있다. 또한 같은 이유 때문에 발진기가 아닌 다른 기능의 회로와 같은 칩 상에 집적이 가능하다는 추가적인 장점이 있다. 따라서, 집적된 시스템 내에서의 신호원 기능을 얻기 위해서는 이러한 트랜지스터 회로 기반 발진기가 크게 선호된다고 할 수 있겠다. 이러한 트랜지스터 회로 기반 발진기로서 고주파 응용에 널리 활용되는 구조로는 LC cross-coupled 발진기, 콜피츠 (Colpitts) 발진기, 링(ring) 발진기 등이 있으며, 아래에 이들 각각에 대한 간단한 동작 설명 및 최근 보고된 특성을 보이도록 한다.
LC cross-coupled 발진기는 그림 9(a)에서 보이는 바와 같이 게이트와 드레인이 서로 엇갈려 연결된 차동 구조의 트랜지스터 쌍이 적절한 LC 공진 회로와 연결된 형태로 구성된다. 이러한 구조가 발진을 하는 원리는 그림 9(b)에서 보여지는 개념도에 기반하여 설명될 수 있다. 간단한 소신호 분석에 따르면 그림에서 보이는 바와 같이 LC 공진 회로 측에서 트랜지스터 차동 구조를 바라본 소신호 저항 값이 음의 값을 보이게 된다. 즉, 엇갈려 연결된 트랜지스터 차동 구조는 부성저항을 나타내게 된다. 이를 그림에서 나타난 바와 같이 적절한 LC 공진 회로와 연결을 하면 특정 주파수에서의 발진이 일어나게 된다. 이러한 부성저항에 기반한 동작 원리는 앞서 설명된 다이오드 기반 발진기와 원칙적으로는 동일하다고 볼 수 있다. 그러나 여기에서 중요한 차이점은 이러한 트랜지스터 회로 기반 접근 방식의 경우, 부성저항을 특수한 소자 구조를 필요로 하지 않고 일반적인 표준 소자에 기반하여 회로적인 기법을 적용하여 얻을 수 있다는 점이다.
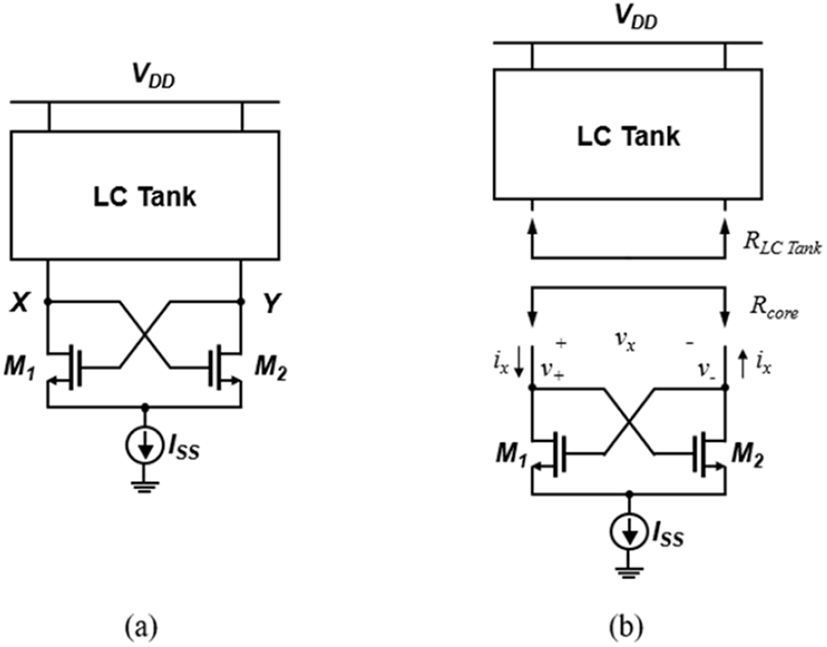
LC cross-coupled 발진기는 뒤에 살펴볼 링 발진기에 비해 안정적이고 위상잡음이 작은 발진 신호를 얻을 수 있는 장점이 있다[11]. 단지 LC 공진기를 회로의 일부로 포함하기 때문에 다소 큰 면적을 차지하게 된다. 그러나 주파수가 증가할수록 파장이 작아짐에 따라 공진기를 구성하는 수동소자의 크기도 작아지게 되어, 테라헤르츠 영역에서는 상대적으로 면적 문제가 덜 부각된다. 또한 이러한 높은 주파수에서는 LC 공진기의 구성을 마이크로스트립 라인과 같은 전송선으로 구현할 수 있다는 점도 면적 문제를 완화시키는 요인이 된다. 테라헤르츠 대역에서의 설계에 있어 또다른 난점으로는 전기적 길이(electrical length) 및 위상이 소자 크기의 작은 변화에도 민감하게 변하기 때문에 특별한 주의가 요구된다는 점을 들 수 있다. 또한 같은 이유로서 소자의 기생성분도 높은 주파수에서는 큰 영향을 끼치기 때문에 설계에 이를 정확하게 반영해야 한다. 이러한 이유 때문에 정밀한 electromagnetic(EM) 시뮬레이션의 역할이 매우 중요해진다. 사실 이러한 측면은 LC cross-coupled 발진기뿐 아니라, 곧 기술될 다른 구조의 발진기, 더 나아가서는 일반적인 고주파 회로 설계에 공통적으로 적용되는 부분이라고 할 수 있겠다.
그림 10은 최근 보고된 LC cross-coupled 발진기의 특성을 보여주고 있다[1]. 주어진 그림에서 드러나듯이 이 구조의 발진기는 특히 Si CMOS 공정에 기반하여 구현된 사례가 많은데, 이는 cross-coupled 구조가 차동 구조를 기반으로 하는 만큼 집적회로에 적합한 구조이며, Si CMOS 가 다른 반도체 공정에 비해 집적회로에 기반하여 발전된 측면이 있기 때문으로 풀이될 수 있겠다. 그림에 따르면 100 GHz~300 GHz 범위에서 0 dBm을 상회하는 출력 전력이 SiGe HBT(heterojunction bipolar transistor)나 III/V HBT뿐 아니라, Si CMOS 공정 기반으로도 얻어지는 것을 볼 수 있다. 주파수 측면에서는 500 GHz 이상의 발진 주파수를 나타내는 사례도 보여지고 있는데, 이는 사용 공정의 소자 동작 주파수를 넘어서는 주파수로서, 기본 주파수(fundamental frequency)가 아닌 고조파(harmonics)를 이용한 결과이다. 실제로 테라헤르츠 대역의 동작을 위해서는 고조파를 활용한 사례가 많으며, 이는 역시 LC cross-coupled 구조뿐 아니라, 다른 구조의 발진기에도 마찬가지로 적용된다.
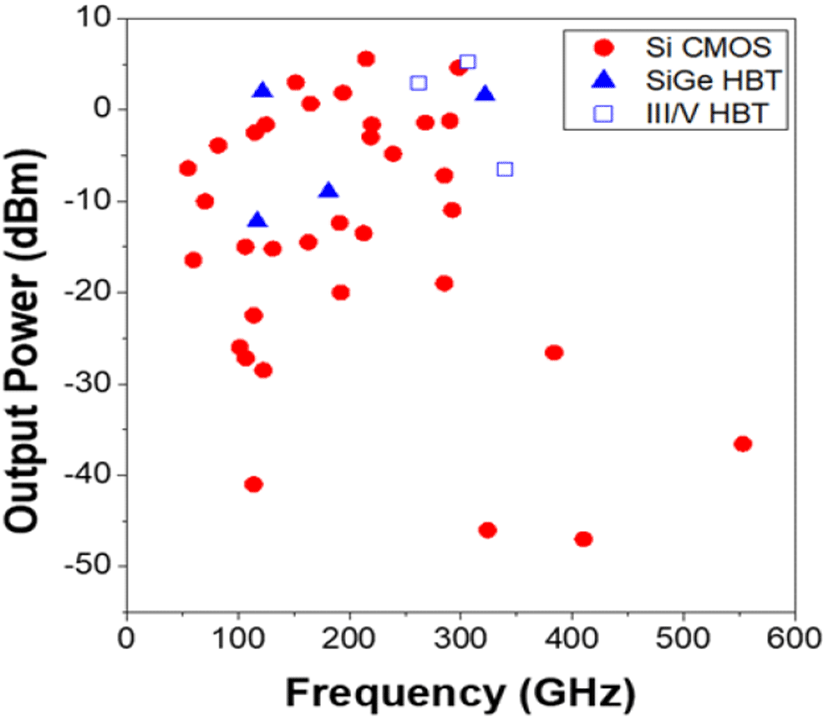
콜피츠 발진기도 기본적으로 LC 공진기에 기반을 두고 있다는 면에서 LC 발진기라고 할 수 있겠다. 단지 LC cross-coupled 발진기와는 다른 회로적 기법을 통하여 부성저항을 얻는다는 점에서 차별성이 있다. 콜피츠 발진기의 기본적인 형태가 그림 11(a)에 나타나 있으며, 이를 통해 발진의 원리가 아래와 같이 설명될 수 있다. 만약 X 지점의 전압이 소량 상승하게 되면 Y 지점의 전압이 역시 상승하게 되며, 이는 M1의 소스 전압의 상승을 가져온다. 소스 전압의 상승은 M1의 VGS를 감소시키게 되어 소자의 드레인 전류값이 작아지며, 이는 로드에서의 전압 강하량을 감소시키게 되어 결과적으로는 X 지점의 전압을 끌어 올리게 된다. 즉, X 지점에서의 초기 전압 상승이 다시 X 지점의 전압을 끌어 올리는 결과를 가져오게 된다. 이는 양성 피드백(positive feedback)에 해당하며, 이에 따라 회로 내에서의 발진이 유도되게 된다. 이 시점에서 왜 굳이 로드에 C1과 C2로 이루어진 캐패시턴스 분리 (capacitive division)가 필요한지 의문이 생기게 된다. C2 가 없어도 위의 설명에 따르면 발진이 일어날 수 있을 것이다. 그러나 실제의 경우에 있어 만약 C2가 없다고 가정을 하면 X 지점에서 소자 쪽을 바라본 임피던스 값이 1/gm(gm은 소자의 트랜스컨덕턴스)이 되는데, 이 값은 그다지 큰 값이 아니다. 이는 LC 공진기에 있어서의 Q 값의 감소를 가져오게 되고, 결국 발진 효율을 감소시키는 결과를 낳게 된다. 그림에서와 같이 콜피츠 발진기의 C1과 C2에 기반한 캐패시턴스 분리 구조는 이 임피던스 값을 (1+C1/C2)2 만큼 증가시키는 효과를 가져오며, 이것이 콜피츠 발진기의 가장 큰 특징이라 할 수 있겠다. 콜피츠 구조는 집적회로가 발명되기 이전에 이미 발진기 구조에 적용되었던 기법이기에, 많은 경우에 있어 그림 11(a)에 나타난 바와 같이 하나의 소자를 사용한 single-ended 구조로도 사용되나, 집적회로에 적용되는 경우, 그림 11(b)에 나타난 바와 같은 차동 구조로도 널리 사용되고 있다[12].
콜피츠 발진기는 기본적으로 LC 발진기라는 측면에서 발생 신호의 품질 및 회로 면적 등에서 앞서 살펴본 바와 같은 LC cross-coupled 발진기와 그 장단점을 같이 한다. 단지 이 구조가 발전해온 궤적의 영향으로 상대적으로 Si CMOS보다는 SiGe이나 III/V HBT 등의 바이폴라 소자 기반으로 활용되는 예가 많으며, 이는 그림 12에 잘 나타나 있다[1]. 그림에서 보여지는 바와 같이 출력 전력 면에서는 LC cross-coupled 구조와 비슷한 값을 나타내지만, 주파수 측면에서 보다 높은 주파수에서의 결과가 보고되고 있다. 특히 최근에는 1 THz를 상회하는 발진 주파수도 보고되어 주목 받은 바가 있다[13].

링 발진기는 앞서 살펴 본 두가지 구조의 발진기와는 달리 LC 공진기에 기반을 두고 있지 않다. 그 대신 인버터 단에 항상 수반되는 시간 지연 효과를 활용하여 발진을 구현한다. 즉 여러 단의 인버터가 직렬로 연결되는 경우, 각 인버터 단에 시간 지연이 발생하는데, 이는 결과적으로 일정한 위상 지연을 수반하게 된다. 이때 그림 13과 같은 인버터 체인의 한쪽 출력단을 다른 쪽 입력단에 연결을 하는 경우, 특정 주파수에 있어서 위상 지연에 의한 양단의 위상차가 180°에 해당하게 된다. 여기에 각 인버터에서 기본적으로 발생하는 180°의 위상을 더하면 양단의 전체 위상차는 180°+ n·180°가 된다(n은 인버터 개수). 만약 n이 홀수라고 가정을 한다면 총 위상차는 360°의 배수가 된다. 입력단에 전압 변화가 있는 경우, 링 발진기를 한바퀴 돌고 난 신호는 다시 기존의 전압 변화에 더해지는 효과를 가져오게 된다. 결과적으로 양성 피드백이 발생하고 이에 따라 발진이 일어나게 된다.
링 발진기는 기본적으로 LC 공진기를 포함하지 않기 때문에 매우 작은 크기로 구현이 가능하다. 단지 LC 기반 발진기에 비해 신호의 안정성이 다소 떨어지고, 이에 따라 위상 잡음이 크게 나타나는 경향이 있다. 이러한 이유로 링 발진기는 많은 경우에 단독으로 사용되기보다는 PLL(phase-locked loop)과 같은 locking 구조 내의 발진기 요소로서 널리 활용이 된다. 링 발진기의 발진 주파수는 인버터 수 n 및 각 인버터의 시간 지연에 반비례를 하게 된다. 이 때문에 높은 발진 주파수를 얻기 위해서는 발진기 구성에 필요한 최소한의 크기로서 흔히 3단 구조로 구성이 된다. 여기에 소자 동작 속도가 뛰어난 공정을 사용하게 되면 시간 지연을 더욱 작게 가져갈 수 있기 때문에 테라헤르츠 응용을 위해서는 보다 동작 속도가 뛰어난 공정을 사용하여야 한다.
최근의 고속 반도체 공정의 개발에 따라 링 발진기의 동작 속도도 증가를 하고 있으며, 500 GHz에 근접하는 결과도 보고되고 있다. 그러나 LC 발진기에 비해서는 그 출력 전력 수준과 발진 주파수는 다소 뒤처지는 면이 있는 것이 사실이다. 하지만 앞서 언급된 바와 같이 작은 면적의 장점이 있기 때문에 고주파 PLL에 흔히 사용이 된다. 그림 14에 지금까지 살펴 본 세가지 구조의 발진기 특성이 비교되어 보여지고 있다[1].
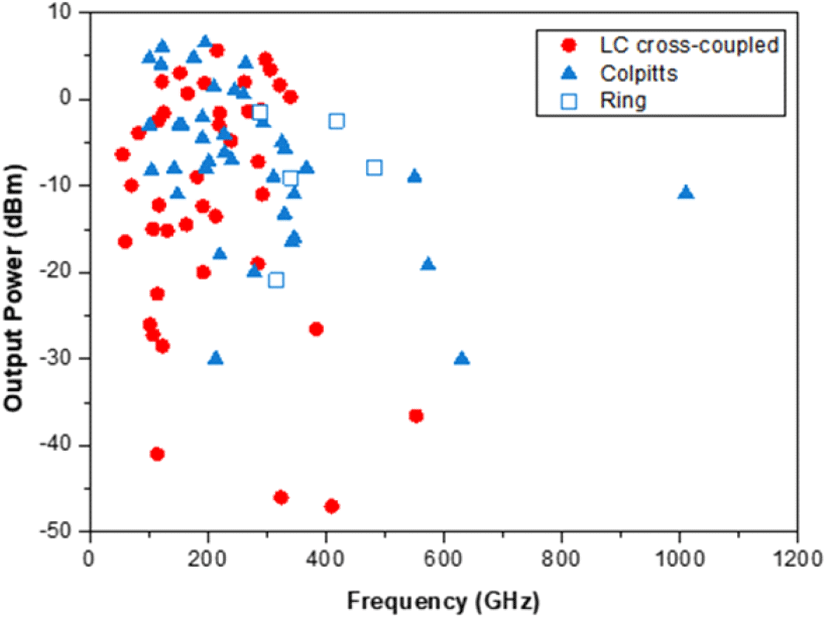
Ⅳ. 테라헤르츠 신호원 예시
지금까지 살펴본 다양한 구조에 기반하여 많은 테라헤르츠 대역에서 동작하는 신호원이 보고되었고, 최근 들어 그 추세가 가속이 되고 있다. 본 절에서는 이들 테라헤르츠 신호원에 대한 몇 가지 사례를 본 연구진에서 개발한 트랜지스터 회로 기반 발진기를 통해 보이고자 한다. Si CMOS, SiGe HBT, InP HBT 등의 다양한 공정에 기반하여 발진기들이 개발된 바 있는데, 이 중 높은 동작 특성에 유리한 InP HBT 기반 발진기를 4가지 소개하도록 한다.
그림 15는 InP HBT 공정 (fT/fmax = 392/859 GHz)에 기반한 300 GHz 발진기의 회로도와 제작된 칩 사진을 보여주고 있다[14]. 이 발진기는 LC cross-coupled 구조에 기반하고 있는데, 일반적인 베이스-컬렉터 간의 coupling이 아닌, 이미터-컬렉터 간의 coupling을 채택하고 있다. 최근 보고에 의하면 100 GHz 이상 대역의 높은 주파수에 있어서는 이러한 구조가 발진 주파수 및 출력 전력 측면에서 이점이 있는 것으로 나타난다[14]. 발진기의 핵심 부분은 cross-coupling 되어 있는 트랜지스터 Q1과 Q2로 구성이 되며, 이 상단에 위치한 Q3과 Q4는 버퍼단을 구성하고 있다. LC 공진기를 구성하는 인덕턴스 성분은 마이크로스트립 라인으로 구현이 되어 있다. 제작된 발진기는 설계 값에서 크게 벗어나지 않는 306 GHz의 발진 주파수를 나타내었고, 이때 소모된 DC 전력은 87.4 mW였다. 생성된 신호의 출력 전력은 5.3 dBm으로 측정이 되었으며, 소모 DC 전력 대비 효율은 3.9 %로 나타났다. 위상잡음도 측정이 되었으며, 10 MHz 오프셋 주파수에서 −116.5 dBc로 나타났다.
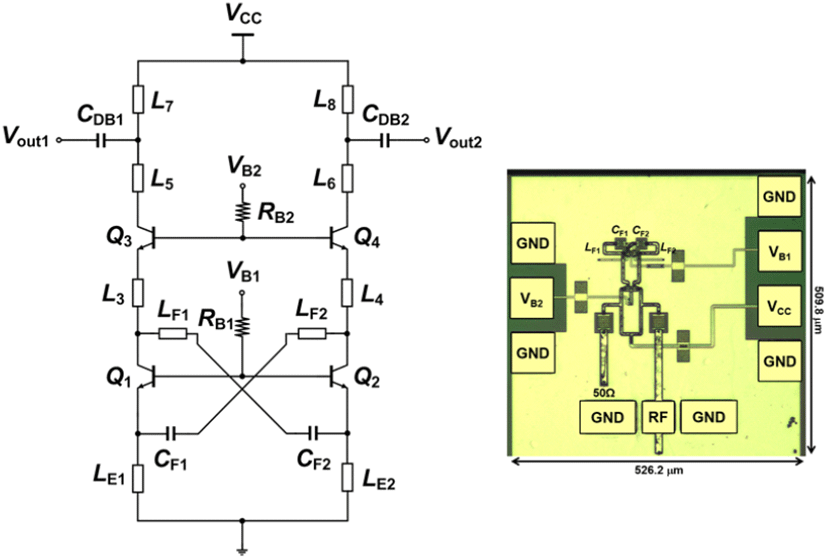
연구의 발전 측면에서 이 300 GHz 발진기를 기본으로 하여 두 가지의 개선 방향이 설정되었다. 그 하나는 출력 전력의 증가, 또 하나는 발진 주파수의 증가이다. 일단 출력 전력의 증가를 위해서는 두 개의 동일한 발진기에 대해 전력 결합을 적용하는 방법을 택하였다. 그림 16은 이러한 전력 결합된 신호원 회로와 제작된 칩 사진을 보여주고 있다[15]. 전력 결합을 위해서는 우선적으로 두 발진기의 위상이 동기화되어야 하는데, 이를 위하여 LCN 과 CCN으로 구성된 coupling 네트워크가 사용되었다. 동기화된 두 개의 발진기에 대해 두 단계에 걸친 전력 결합이 적용되었다. 첫 단계는 차동 구조를 가지는 각 개별 발진기의 두 차동 출력단에서 발생하는 전력을 결합하는 단계로서 각 발진기에 대해 rat-race coupler를 적용하였다. 두 번째 단계는 각 rat-race coupler로 결합된 두 출력 전력을 윌킨슨 전력 결합기를 사용하여 결합하는 단계이다. 이들 전력 결합이 그림 16에 도시화되어 있다. 제작된 신호원은 10 dBm의 향상된 출력 전력을 보여주었으며, 이때 소모된 DC 전력은 196 mW였다. 발진 주파수는 개별 발진 주파수보다 다소 내려간 276 GHz로 측정되었는데, 이는 두 발진기를 결합하기 위해 추가된 coupling 네트워크나 rat-race coupler의 영향인 것으로 추측이 된다.
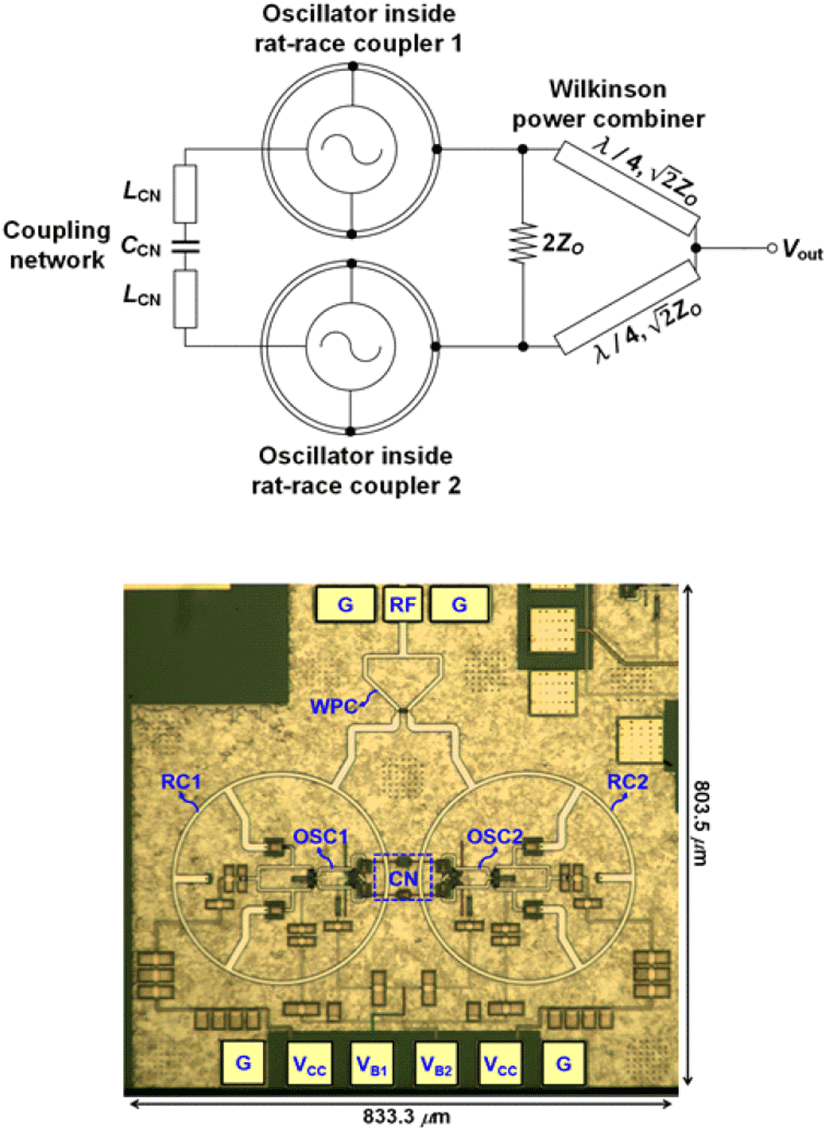
앞서 언급된 또 하나의 발전 방향은 발진 주파수의 향상이다. 이를 위하여 앞서의 300 GHz 발진기에 기반을 두되, 제2 고조파를 추출할 수 있는 push-push 방식의 구조를 적용하였다. 결과적으로 구성된 600 GHz 발진기의 회로도가 그림 17에 나타나 있다[16]. 이 회로는 기본적으로 300 GHz 발진기와 동일한 핵심 구조를 유지하되, 컬렉터 공동 노드에서 발생하는 제2 고조파를 출력으로 내보내는 구조를 채택하고 있다. 출력단에는 기본 주파수 신호를 억제하기 위한 수동 회로 네트워크가 구성이 되어 있으며, 능동 버퍼 구조의 부재로 인해 300 GHz 발진기에 비해 오히려 더 단순한 구조로 구현되었다. 그림 17 에 보여진 제작된 발진기는 설계값과 유사한 600 GHz 근처의 발진 주파수 값을 보였으며, 바이어스 전압의 조정에 따라 562 GHz에서 645 GHz에 이르는 범위 내에서 주파수 조율이 가능한 것으로 나타났다. 최대 출력 전력은 591 GHz에서 −17.4 dBm으로 측정되었으며, 이때 DC 전력 소모는 49.3 mW 였다.
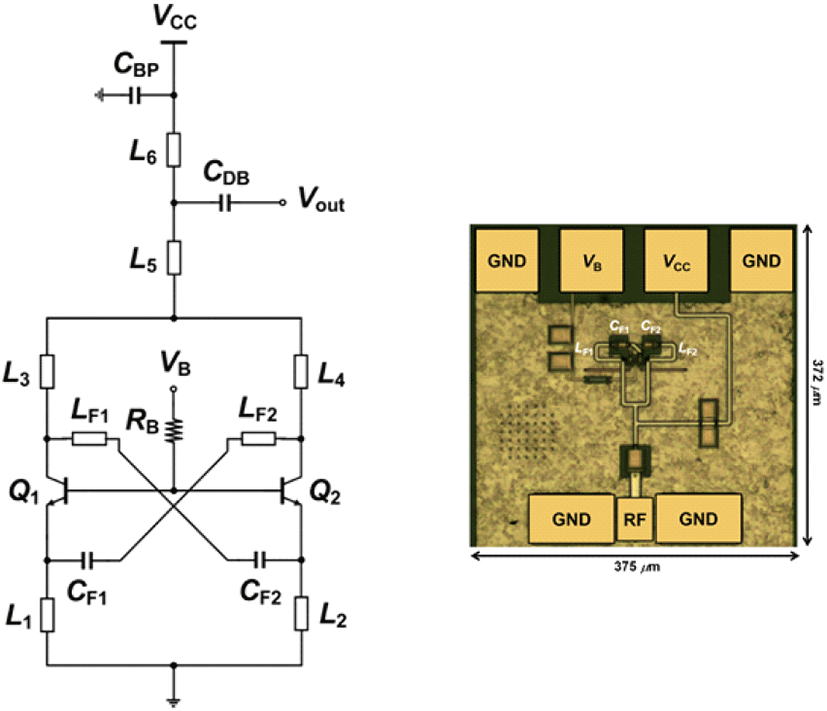
제작된 600 GHz 발진기의 성능을 추가로 향상시키기 위하여 cross-coupling을 이미터와 컬렉터를 직접 연결하는 대신 두 개의 마이크로스트립 라인으로 구성된 coupled line 구조를 통하여 연결이 되는 구조를 적용한 발진기가 그림 18에 나타나 있다[17],[18]. 이와 같은 coupling 구조를 사용하는 경우, cross-coupling에 부득이 수반되었던 coupling capacitor 및 coupling 경로(예를 들어 그림 15의 CF1과 CF2, LF1과 LF2)를 제거할 수 있으며, 이에 따라 이들 소자에 의한 손실의 방지와 함께 더욱 작은 회로 면적의 구현이 가능하다. 그림 18에 제작된 coupled-line 발진기가 나타나 있다. 이 회로는 633 GHz의 발진 주파수에서 −11.2 dBm의 측정된 출력 전력 값을 보여 주었으며, 설계에서 의도한 바와 같이 발진 주파수와 출력 전력에서의 향상을 가져왔다. 해당 조건에서의 DC 전력 소모는 50.6 mW 로서 0.15 %의 효율을 나타내었다.
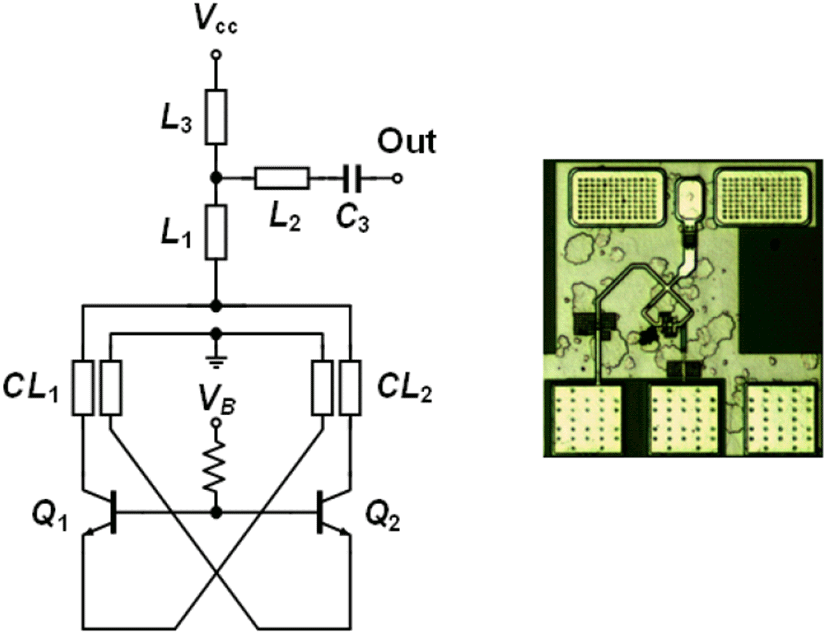
Ⅴ. 결 론
지금까지 여러 가지 구조의 다이오드 및 트랜지스터 회로에 기반한 테라헤르츠 신호원 동작 원리 및 성능 경향을 살펴 보았고, 몇 가지의 InP HBT 공정 기반 테라헤르츠 신호원에 대해 그 회로 구조 및 특성을 소개하였다. 테라헤르츠 신호원은 현재 큰 관심과 함께 부상하고 있는 차세대 무선 통신 시스템 및 다양한 이미징/분광 응용에 필수적인 요소로서 적용될 것으로 예측이 되고 있다. 특히 반도체 기반 신호원의 경우, 작은 크기와 작은 전력 소모의 특성으로 이동 가능한 송신단에 적절하게 적용될 수 있을 것으로 예상되기 때문에 이에 대한 연구가 앞으로도 지속적으로 진행되어야 할 것이다.