Ⅰ. 서 론
GaN HEMT 소자는 높은 전자이동도, 열전도도 및 항복전압 등의 특성을 가지고 있어 최근 능동 위상배열 레이다 안테나 시스템에 사용되어지는 송수신모듈의 전력 증폭기에 적용이 되는 추세이다[1],[2]. GaN HEMT 소자를 사용한 고출력 전력증폭기 설계에서 입출력 정합회로를 이용하여 트랜지스터의 최적 소스 및 로드 임피던스에 정합시키는 과정은 필수이다. 이러한 최적의 임피던스를 구하기 위해서는 소자의 비선형 특성들이 반영된 시뮬레이션 모델이 필요하다. 이러한 비선형 모델을 이용하여 시뮬레이션을 통해 최적의 임피던스를 구하거나 실험적으로 로드-풀 측정을 통해 각 임피던스 점에 대한 트랜지스터의 출력 전력, 전력 이득 및 효율 성능을 측정하여 요구 성능을 만족하는 최적의 부하 임피던스가 결정된다.
본 논문에서는 비선형 모델링을 위한 Pulsed I-V 및 S-parameters 측정을 하고, 측정값을 이용하여 선형/비선형 파라미터 추출을 하는 비선형 모델링 방법 및 과정들에 대해서 기술한다. 다양한 비선형 모델링 기법 중에서 본 논문에서는 컴팩트 모델링 기법을 적용하였다. 물리적 모델이나 PHD(polyharmonic distortion) 모델에 비해 모델링 구현이 용이하고, 해석시간을 줄일 수 있는 장점이 있다[3]. 최종적으로는 비선형 모델을 검증하기 위해 비선형 모델을 이용한 시뮬레이션 결과와 능동 로드-풀 측정 결과를 통해 얻은 GaN HEMT 소자의 성능을 비교하여 소자의 측정 및 비선형 모델링에 대해서 검증한다.
Ⅱ. 본 론
대신호 모델링에 사용된 단위소자는 웨이비스에서 제작한 GaN HEMT 소자이고, 그림 1은 단위소자의 광학현미경 사진을 나타낸다. 0.4 μm의 게이트를 가지는 GaN HEMT소자로 4인치 반절연 SiC 기판위에 제작되었다. 10개의 게이트 핑거를 가지고 있으며, 각각의 게이트의 폭은 350 μm이다. 금도금으로 형성된 소스연결필드 플레이트를 가지고 있고, 후면금속막은 전면 소스오믹금속에 관통비아로(through hole via) 연결되어 있다. 제작된 GaN HEMT 소자를 이용하여 비선형 모델링에 필요한 파라미터들을 추출하기 위해 여러 조건에서 Pulsed I-V 및 S-parameters를 측정하였다. 파라미터 측정은 AMCAD사 PIV200과 키사이트 테크놀로지스 PNA-X를 측정 제어 시뮬레이션 툴인 AMCAD사 IVCAD를 이용하여 측정하였다. Pulsed bias 및 RF source의 측정 조건으로는 각각 1 μs 의 펄스 폭과 3 % 듀티 사이클 및 0.6 μs의 펄스 폭과 2 % 듀티 사이클의 조건으로 측정을 하였다.
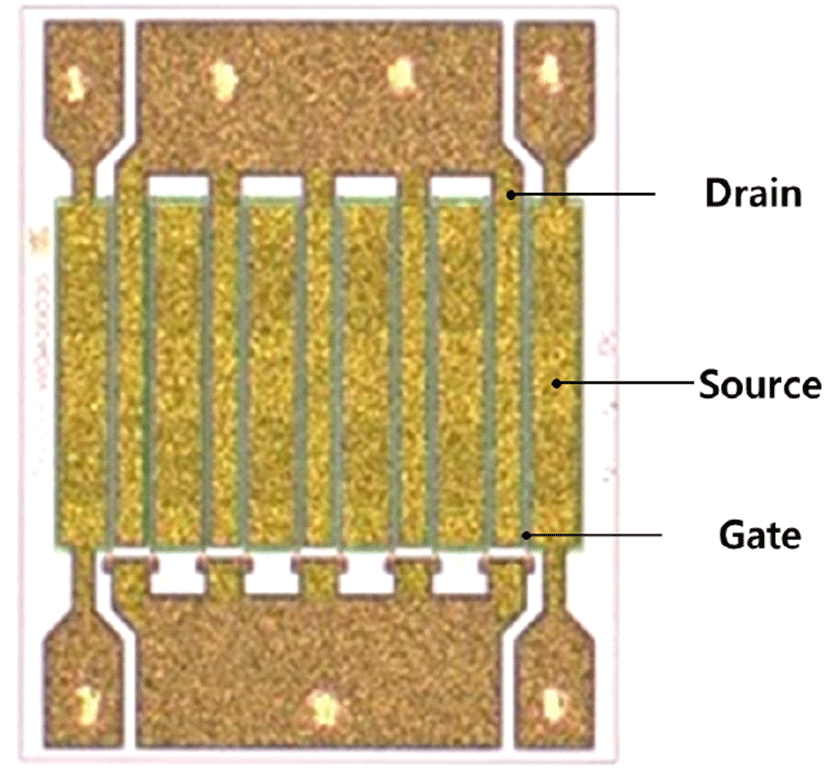
비선형 모델링을 위한 파라미터 측정은 먼저 샘플 선택을 위한 Idss (포화 드레인 전류)와 gm (트랜스컨덕턴스)을 측정한다. 본 논문에서는 웨이비스 GaN HEMT 샘플 10개를 이용하여 각각의 평균값에서 편차가 큰 샘플을 제외하는 방법을 선택하였다. 선택된 샘플을 이용하여 선형 및 비선형 모델 파라미터를 추출하기 위하여 상온에서 Pulsed I-V와 S-parameters을 측정한다. 그 다음은 드레인 전압 40 V와 드레인전류 350 mA일 때, 상온에서 측정한 다음으로 열 저항(Rth) 값을 추출하기 위해 전력 소모에 따른 드레인 펄스 전류를 측정한 값과 척의 온도 가변에 따른 드레인 전류 값을 측정하여 Del Alamo method 를 이용하였고[4], 본 논문에서는 3.74 ℃/W 값의 열 저항 값을 얻었다. 열 커패시턴스(Cth) 값을 구하기 위해서는 상온에서 장 펄스(10 s) 특성 측정값을 이용한다.
지금까지 측정한 결과들을 이용하여 다음 절에서 비선형 모델링을 진행한다.
본 논문의 비선형 모델은 AMCAD HEMT1 model을 이용하였으며, AMCAD HEMT1 model은 펄스 전압 전류 측정들에 최적화 되어 있는 GaN HEMT 비선형 모델링 방법을 제공한다. 비선형 모델링의 절차는 먼저, 측정된 S-parameters를 이용하여 선형 파라미터를 추출하고, 측정된 Pulsed I-V를 이용하여 IV 모델을 추출한다. 그 다음으로 측정된 Pulsed I-V와 S-parameters를 이용하여 비선형 커패시턴스를 추출하고, 열 모델을 위해 Rth와 Cth를 추출한다. 이러한 모델링 과정을 거쳐 Load-pull을 통해 소자 모델링을 검증하게 되는데, 측정값과 모델링한 값이 유사하지 않는다면 처음의 단계로 돌아가 다시 모델링을 진행한다.
그림 2는 GaN HEMT 소자의 비선형 모델링 결과를 이용한 S-parameters 시뮬레이션 결과와 측정 결과를 나타낸다. 측정 및 시뮬레이션은 0.5 GHz에서 26 GHz까지 0.25 GHz 간격으로 드레인 전압 40 V 및 드레인 전류 350 mA의 조건에 맞게 게이트 전압을 조정하여 결과를 얻었다. 측정값과 시뮬레이션 결과가 거의 일치함을 확인할 수 있다. 그림 3은 Pulsed 전압 전류 측정 및 시뮬레이션 결과 비교를 나타낸다. 측정 및 시뮬레이션은 3.2 GHz에서 드레인 전압 및 게이트 전압을 가변하며 진행하였다.

앞에서 비선형 모델링을 위한 측정과 그 측정값을 이용하여 비선형 모델링한 결과를 최종적으로 검증하기 위해 본 논문에서는 Maury Microwave사의 MT1000 하이브리드 능동 로드-풀 시스템과 GaN HEMT 단위 소자를 측정하기 위한 프로브 스테이션을 이용하였다. 하이브리드 능동 로드-풀 시스템은 능동 로드-풀 시스템 출력쪽에 자동 튜너를 추가하여 능동 로드-풀 시스템에 필요한 RF 전력보다 더 적은 출력 전력을 갖는 증폭기를 시험구성에 사용할 수 있다. 시험 구성은 PXI baseband synthesizer / analyzer, RF test set, 자동 튜너 및 펄스 바이어스 인가와 측정을 위한 AMCAD PIV 장비로 구성된다. 그림 4는 능동 로드-풀 측정 결과를 나타낸다. 최대 출력점과 최대 효율점을 나타내었으며, 최대 효율 임피던스는 소스 임피던스 2.358+3.865i Ω과 로드 임피던스 20.02+20.87i Ω 일 때 최대 22 W의 출력 전력, 16.1 dB 전력 이득 및 62.2 %의 드레인 효율을 얻을 수 있었다. 최대 출력 임피던스 조건은 소스 임피던스는 최대 효율 임피던스와 동일하게 고정시키고, 로드 임피던스를 가변시키며, 찾은 점은 17.43 +10.09i Ω이고, 최대 25.6 W의 출력 전력, 17.1 dB의 전력 이득 및 56 %의 드레인 효율을 얻었다.
그림 5는 비선형 모델링 검증을 위해 로드-풀 측정 결과를 비선형 모델링 결과를 이용한 시뮬레이션과 비교 하였다. 표 1과 같이 최대 출력점에서 시뮬레이션 결과는 최대 출력 22.6 W, 전력 이득 15.6 dB 및 드레인 효율 58 %의 결과를 얻었고, 이는 측정 결과와 출력은 0.54 dB, 전력 이득은 1.5 dB 및 드레인 효율은 2 % 차이가 있음을 확인하였다. 표 2는 최대 효율점에서 측정 결과와 시뮬레이션을 비교하였다. 비선형 모델을 이용하여 시뮬레이션한 결과는 최대 출력 18.2 W, 14.6 dB 전력 이득 및 63.2 % 드레인 효율을 얻었고, 이는 로드-풀 측정 결과와 비교하면 출력은 0.8 dB, 전력 이득은 1.5 dB 및 드레인 효율은 1 %의 오차를 확인할 수 있다.
| Measurement | Simulation | |
|---|---|---|
| Output power [dBm] | 44.09 | 43.55 |
| Power gain [dB] | 17.1 | 15.6 |
| Drain efficiency [%] | 56 | 58 |
| Measurement | Simulation | |
|---|---|---|
| Output power [dBm] | 43.4 | 42.6 |
| Power gain [dB] | 16.1 | 14.6 |
| Drain efficiency [%] | 62.2 | 63.2 |










