Ⅰ. 서 론
GaN(Gallium Nitride) 소자 기술의 발달과 더불어, 최근 이동통신, 위성통신 및 레이다 등의 RF 부품 및 시스템에서 GaN 소자를 채택하기 위한 움직임이 활발하다. GaN 소자는 기존의 LDMOS(Laterally Diffused Metal Oxide Semiconductor) 소자와 갈륨비소(Gallium-Arsenide) 소자에 비해 넓은 에너지 갭으로 인한 고전압 동작, 높은 캐리어농도로 인한 고 전류밀도와 고 전력밀도 특성으로 인하여 고출력·고효율·소형의 전력증폭기에 적합하다[1]~[5].
오랜 기간 동안 RF 부품의 출력과 효율을 높이기 위하여 GaAs 기반의 MMIC 고출력 증폭기가 사용되어 왔으나, 최근 몇 년 전부터 GaN 반도체 공정과 신뢰성이 개선되면서 기존의 III-V족 화합물 반도체 파운드리를 보유한 회사들을 중심으로 GaN 기반의 MMIC(Monolithic Microwave Integrated Circuit) 기술 개발이 활발하게 이루어지고 있으며, 이미 상당한 수준에 이르렀다. 더욱이 외국 파운드리를 이용한 GaN MMIC 개발은 EL(Export License) 승인 문제로 인하여, 국내에서 개발이 쉽지 않은 상황이다. 이러한 세계적인 기술동향과 기술 독점에 대응하고, 국내의 GaN 기술을 확보하고자 한국전자통신연구원(ETRI)은 최근 몇 년 동안 0.25 μm GaN MMIC 관련 기술을 구축하여 왔다.
본 논문에서는 한국전자통신연구원에서 구축한 0.25 μm GaN MMIC 공정 및 소자 특성을 소개하고, 이를 이용한 X-대역 3 W GaN 전력증폭기 MMIC 설계 및 제작결과를 논의한다. X-대역 GaN 전력증폭기 MMIC 설계 및 제작을 통하여 ETRI 0.25 μm GaN MMIC 공정 및 소자특성을 평가하고 분석한다.
Ⅱ. ETRI 0.25 μm GaN MMIC 제작 공정
ETRI GaN HEMT 소자 구조 및 MMIC 제작에 이용된 에피 웨이퍼의 구조는 그림 1과 같다. 적용된 에피구조는 AlGaN/GaN 단일 이종접합 구조로써, 4인치 SiC 기판 위에 MOCVD(Metal Organic Chemical Vapor Deposition) 방식으로 성장되었으며, 도핑되지 않은 25 nm Al0.25Ga0.75N 층과 2 μm GaN 층의 접합에 의해 2-DEG(Dimensional Electron Gas)가 형성되는 구조로 구성된다.
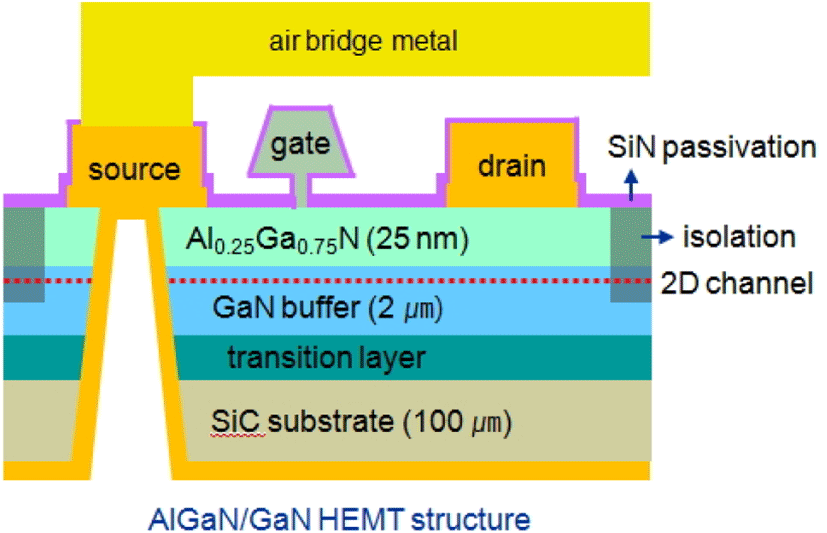
소자 제작은 능동소자, 수동소자 및 배선이 일괄 제작될 수 있도록 수행되었으며, 제작공정 순서는 그림 2와 같다. 소자의 소스 및 드레인 전극을 제작하기 위해, 오믹접촉을 형성시키는 오믹접촉공정이 수행되었으며, 오믹접촉을 위한 금속층은 Ti/Al/Ni/Au 복합금속층이 이용되었다. 오믹 금속층 증착 후, 금속열처리 공정이 900°C에서 50초간 수행되어 오믹접촉을 형성시켰으며, 접촉저항은 약 0.5 Ω·cm이었으며, 기판의 면 저항은 425 Ω/sq 정도의 값을 나타내었다(그림 3). 그림 3의 (5, 2), (5, 5) 및 (5, 8)은 웨이퍼 내에서 패턴의 (x, y) 위치 정보이다. 소자의 활성영역을 정의하기 위해, 본 논문에서는 mesa 식각 공정이 아닌 phosphorus 이온의 이온주입 공정이 수행되었으며, 50 nm 두께의 실리콘질화막을 증착하는 passivation 공정을 수행하였다. TFR(Thin Film Resistor) 제작을 위해 NiCr을 e-beam evaporator 장비를 이용하여 증착하였고, Ti/Au 금속층을 증착하여 소자 전극과 연결되는 배선을 제작하였다.
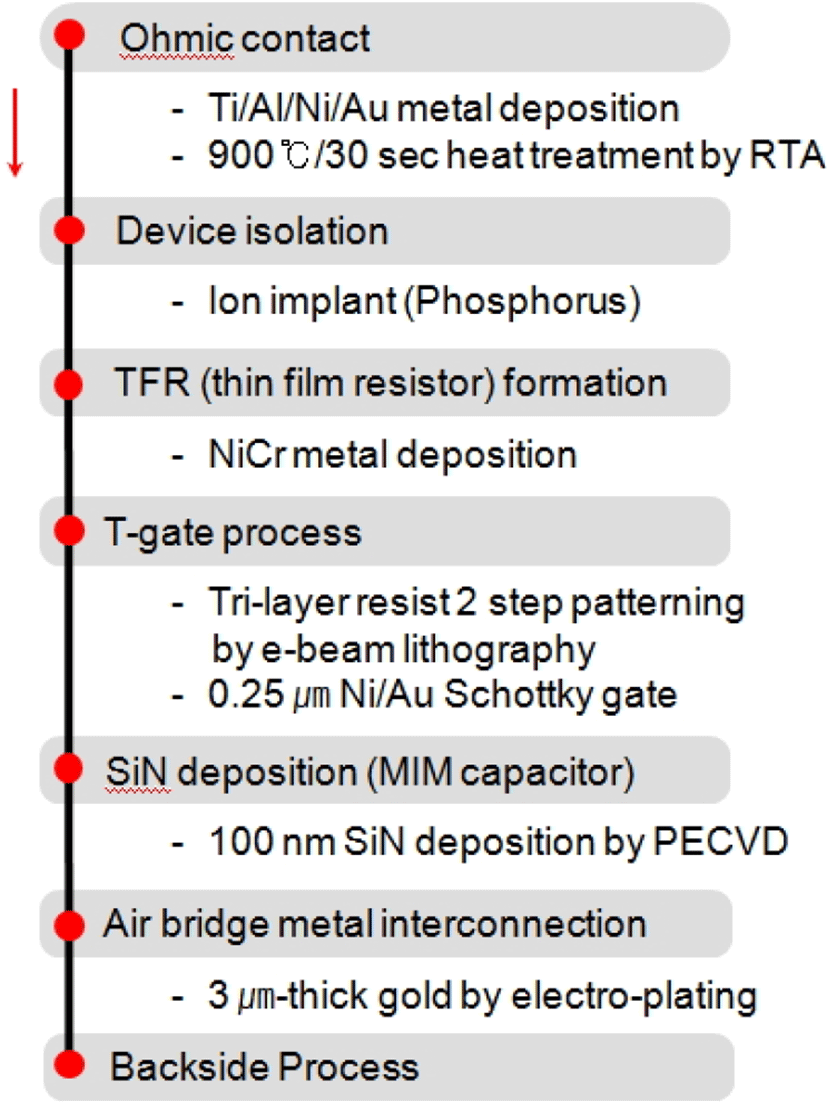
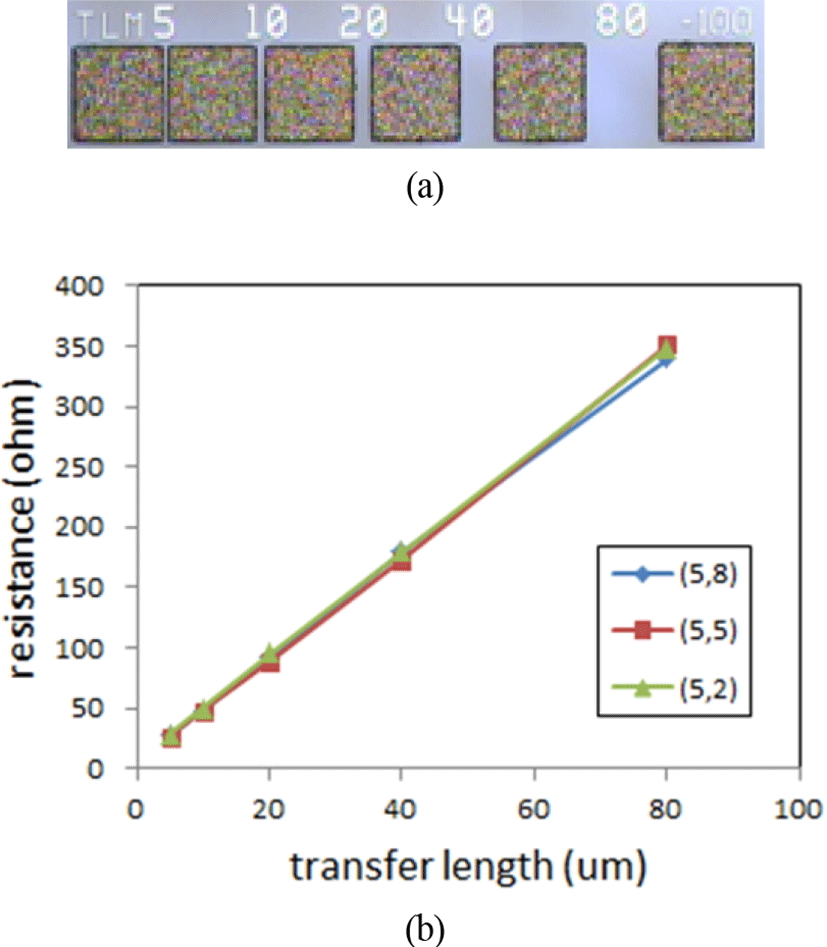
Gate foot 패턴을 형성하기 위해 PMMA 레지스트에 대해서 e-beam 리소그라피 공정을 수행하여, 250 nm급 gate foot 패턴을 제작하였고, 이를 RIE(Reactive Ion Etching) 공정을 통해 실리콘질화막에 전사하였다. 이후 T-gate head 영역을 패터닝하기 위해, PMMA/Copolymer/PMMA 3층 레지스트에 대해서 e-beam 리소그라피 공정을 적용하여 T-형태의 게이트 패턴을 형성시켰다. 상기 패턴을 이용하여 Ni/Au 금속층을 증착시켜 게이트 전극을 제작하였다(그림 4).
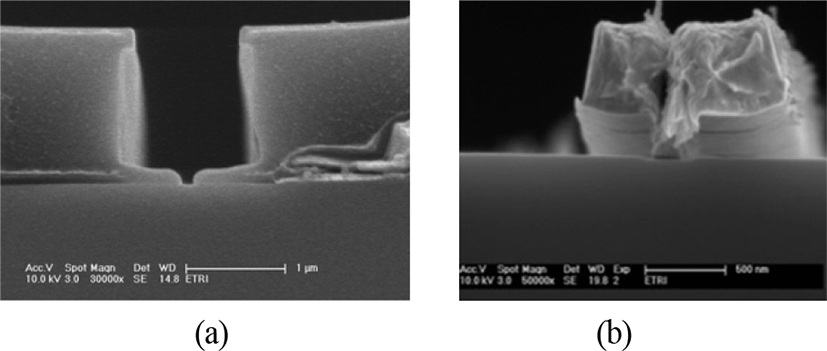
게이트 전극 제작 후, MIM(Metal Insulator Metal) 커패시터 제작을 위한 실리콘질화막을 증착하고, 인덕터 제작 및 배선 연결을 위한 air-bridge 및 Au-plating 공정을 수행하였다. 전면공정 완료 후 기판을 100 μm 두께로 thinning 하는 공정을 수행하고, 비아 홀 패턴을 갖는 Ni 마스 크 층을 형성한 후, SiC 기판을 식각하고, 최종적으로 Au-plating을 수행하는 후면 공정을 수행하였다. 그림 5는 SiC 기판의 식각 후 비아 홀 단면 SEM 이미지이며, 그림 6은 ETRI 0.25 μm GaN 공정을 수행하여 제작된 4인치 GaN 웨이퍼 및 MMIC의 능동소자에 적용된 총 게이트 폭 800 μm의 ETRI GaN 소자이다. MMIC 제작에 적용된 ETRI GaN 능동소자는 소스와 드레인 간격이 5 μm이고, 단위 게이트 폭이 100 μm인 8 finger 게이트로 구성되는 총 게이트 폭이 800 μm의 소자이다. 수동소자로는 저항, 커패시터 및 인덕터가 제작되었다. 저항은 에피기판의 2-DEG 채널 저항을 사용하는 채널저항과 NiCr thin film 저항을 사용하는 TFR 형태로 제작되었으며, 커패시터는 ETRI PECVD(Plasma-Enhanced Chemical Vapor Deposition) 장비에서 증착된 실리콘질화막(ε=6~7)을 유전층으로 사용하는 MIM 커패시터로 제작되었고, 인덕터는 실리콘질화막이 증착된 기판 상에 나선형 형태의 3 μm 두께의 Au 배선으로 제작되었다.
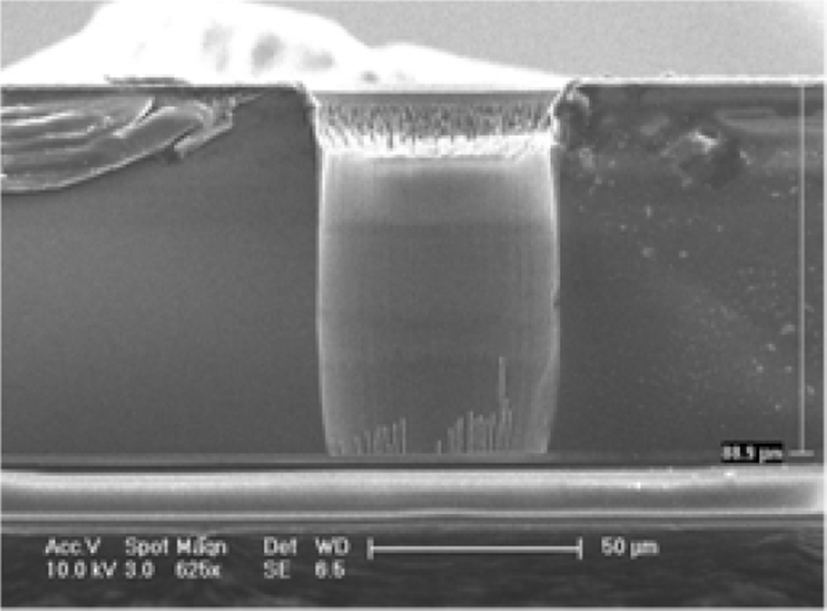
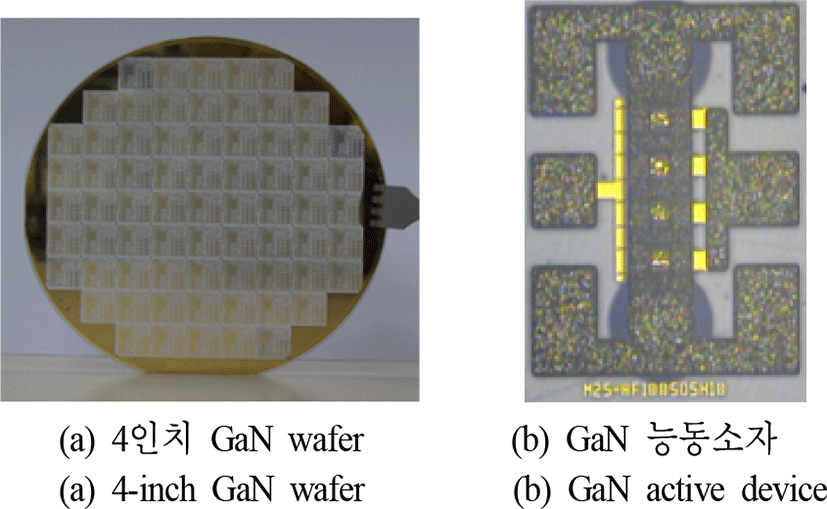
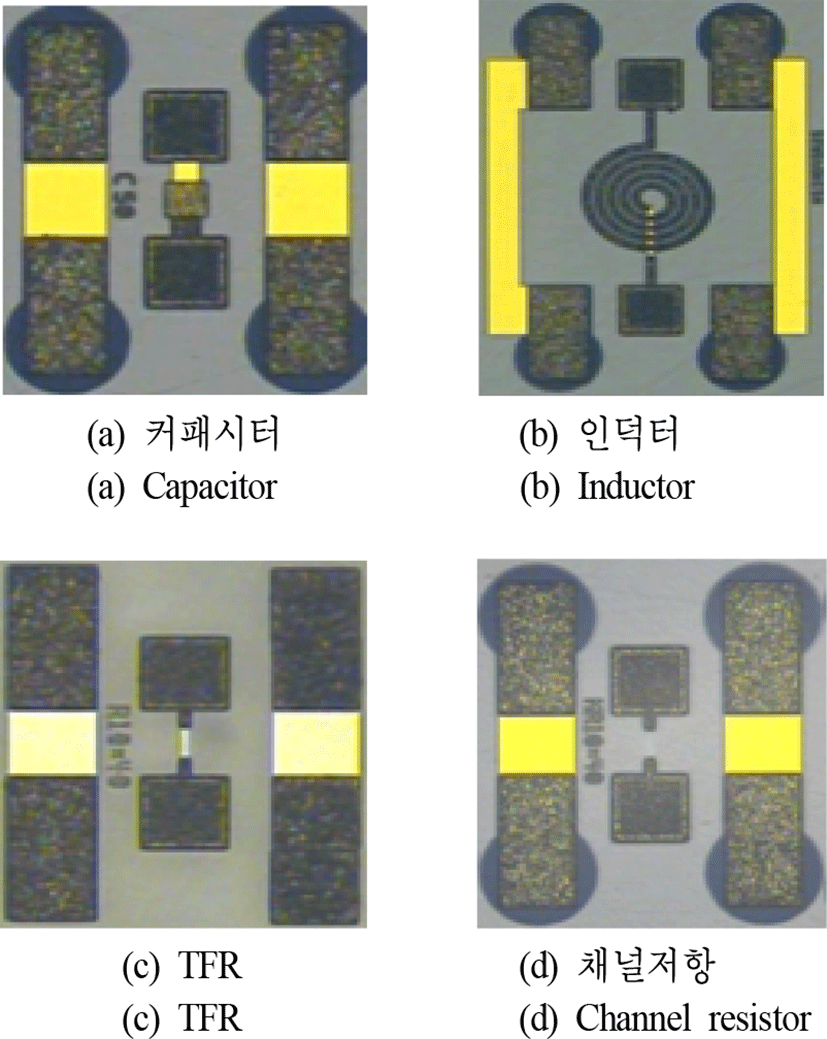
Ⅲ. ETRI 0.25 μm GaN MMIC 소자 특성
ETRI 0.25 μm GaN MMIC 설계시 사용되는 기본 능동소자는 총 게이트 폭이 800 μm인 AlGaN/GaN HEMT(단위 게이트폭이 100 μm인 8 finger 게이트로 구성된 소자)이며, 수동소자는 저항(채널저항 및 TFR), 커패시터 및 인덕터이다.
총 게이트 폭이 800 μm인 AlGaN/GaN HEMT 기본 능 동소자의 DC 및 RF 특성은 그림 8과 같다. 그림 8에서와 같이, Vd=20 V에서 최대 트랜스컨덕턴스와 차단주파수가 각각 300 mS/mm와 55 GHz 이상(Vg=−2 V)이다. 총 게이트 폭이 800 μm인 AlGaN/GaN HEMT 능동소자의 특성을 표 1에 요약하였다. 최대발진주파수는 20 dB/dec로 추정하였으며, 그림 8(c)에서처럼 이득이 더 빠르게 감소하여 실제보다 overestimate 되었을 수 있다.
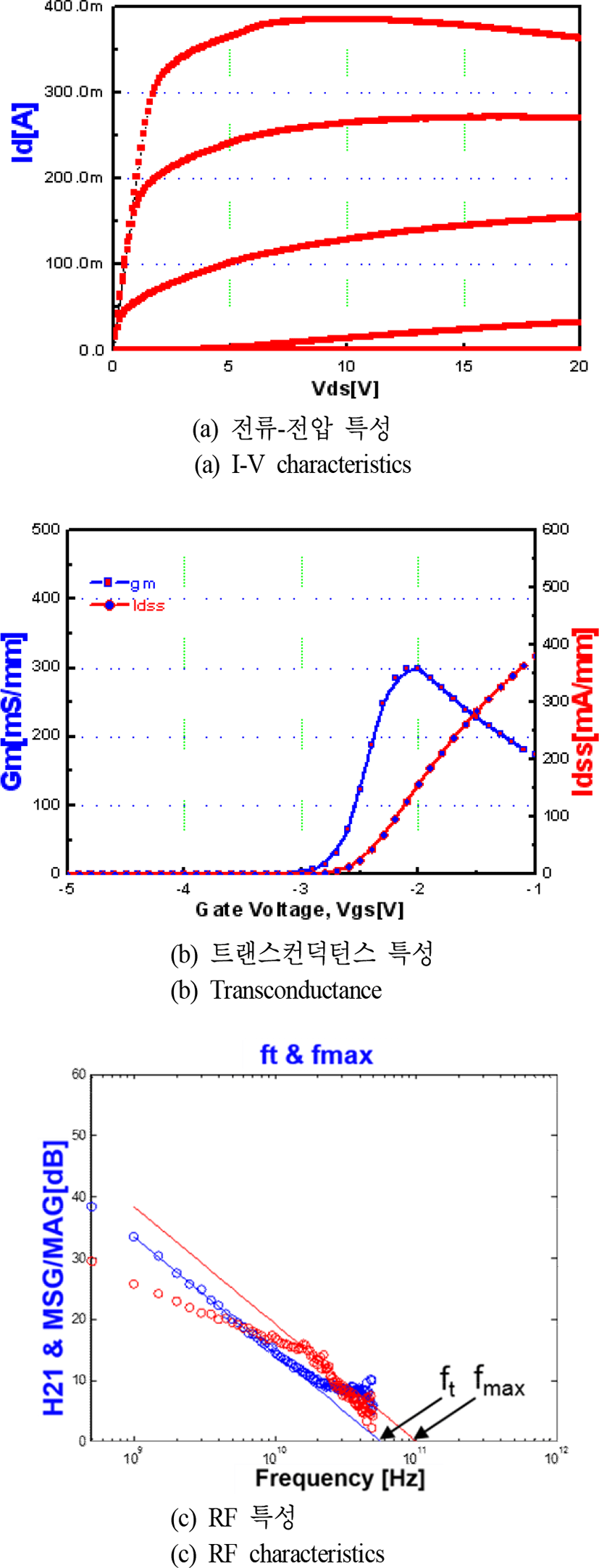
| 항목 | 총 게이트폭 800 μm 소자 |
|---|---|
| 최대 트랜스컨덕턴스 (mS/mm) | 300 |
| 드레인 포화전류(mA/mm) | >519 |
| 차단주파수(GHz) | >55 |
| 최대발진주파수 (GHz) | >100 |
수동소자 특성은 다음과 같다. 먼저, 저항인 채널저항은 425 Ω/sq이며, TFR은 25 Ω/sq이다. MIM 커패시터의 단위 커패시턴스는 0.61 fF/μm2이다. 나선형 인덕터는 반경 25 μm, 50 μm 및 100 μm 각각에 대하여 1.5 turn, 2.5 turn, 3.5 turn 및 4.5 turn으로 설계되어 있으며, 0.1~7.1 nH의 값을 갖는다.
ETRI 0.25 μm AlGaN/GaN HEMT 능동소자 모델은 Keysight사의 ADS Angelov-GaN 모델을 사용하며[6], 수동소자 모델은 lumped element를 사용한 등가회로를 사용한다[7],[8].
Ⅳ. X-대역 3 W GaN 전력증폭기 MMIC 설계 및 제작
ETRI 0.25 μm GaN HEMT 소자를 이용하여, X-대역 3 W GaN 전력증폭기 MMIC를 설계하고 제작하였다.
X-대역 3 W GaN 전력증폭기 MMIC 설계방법은 다음과 같다. 먼저, X-대역 3 W GaN 전력증폭기 MMIC(9 GHz) 설계는 최대전력 3 W를 만족하기 위하여 총 게이트 폭이 800 μm인 AlGaN/GaN HEMT 기본소자 1개를 사용하였다. X-대역 3 W GaN 전력증폭기 MMIC 회로도는 그림 9(a)와 같으며, 총 게이트 폭이 800 μm인 AlGaN/GaN HEMT 소자의 출력이 최대가 되도록 설계하였다. 먼저, 드레인 전압 28 V, 주파수 9 GHz에서 그림 9(b)와 같이 로프-풀 시뮬레이션을 통하여 소자의 전력이 최대가 되는 임피던스를 구한 후, 소자의 출력이 최대인 입출력 임피던스와 등가인 입출력 정합회로를 설계하여 소자와 결합한 후 입출력 정합회로를 최적화하였다. X-대역 3 W GaN 전력증폭기 MMIC의 입출력 정합회로는 모두 수동소자를 사용하여 설계하였으며, ETRI 0.25 μm GaN MMIC 공정규칙에 의해 레이아웃을 수행하였다. 최종적 으로 레이아웃 효과를 반영하여 설계를 완료하였다. X-대역 3 W GaN 전력증폭기 MMIC의 로드-풀 시뮬레이션에 의한 임피던스와 최대 출력 전력은 표 2와 같다.

| 항목 | 소스 | 로드 |
|---|---|---|
| 임피던스 | 3.2+j12.5 | 0.95+j11.3 |
| 최대 출력 전력 | 35.0 dBm | |
제작된 X-대역 3 W GaN 전력증폭기 MMIC 칩 및 측정은 그림 10과 같으며, 제작된 X-대역 3 W GaN 전력증폭기 MMIC 칩의 크기는 1.21×0.88 mm2이다. 측정을 위해 제작된 칩을 보드에 부착한 후, DC 바이어스를 가하고, RF 프로브를 사용하여 CW 조건에서 전력특성과 S-파라 미터 측정을 하였다. 9 GHz에서 측정한 그림 11의 결과와 같이, 출력전력은 35.3 dBm(3.5 W), 전력이득은 10 dB, 전력부가효율(PAE)는 35 %를 얻었으며, S11과 S22는 각각 −17 dB 이하와 −10 dB 이하이다. 그림 11(b)에서와 같이, 출력 정합은 1 GHz 정도 하향 천이(shift)되었으며, 이는 설계에 사용된 모델링 소자와 제작한 MMIC 소자의 문턱전압 천이와 일부 수동소자 특성의 변화에 기인한 것으로 사료된다.

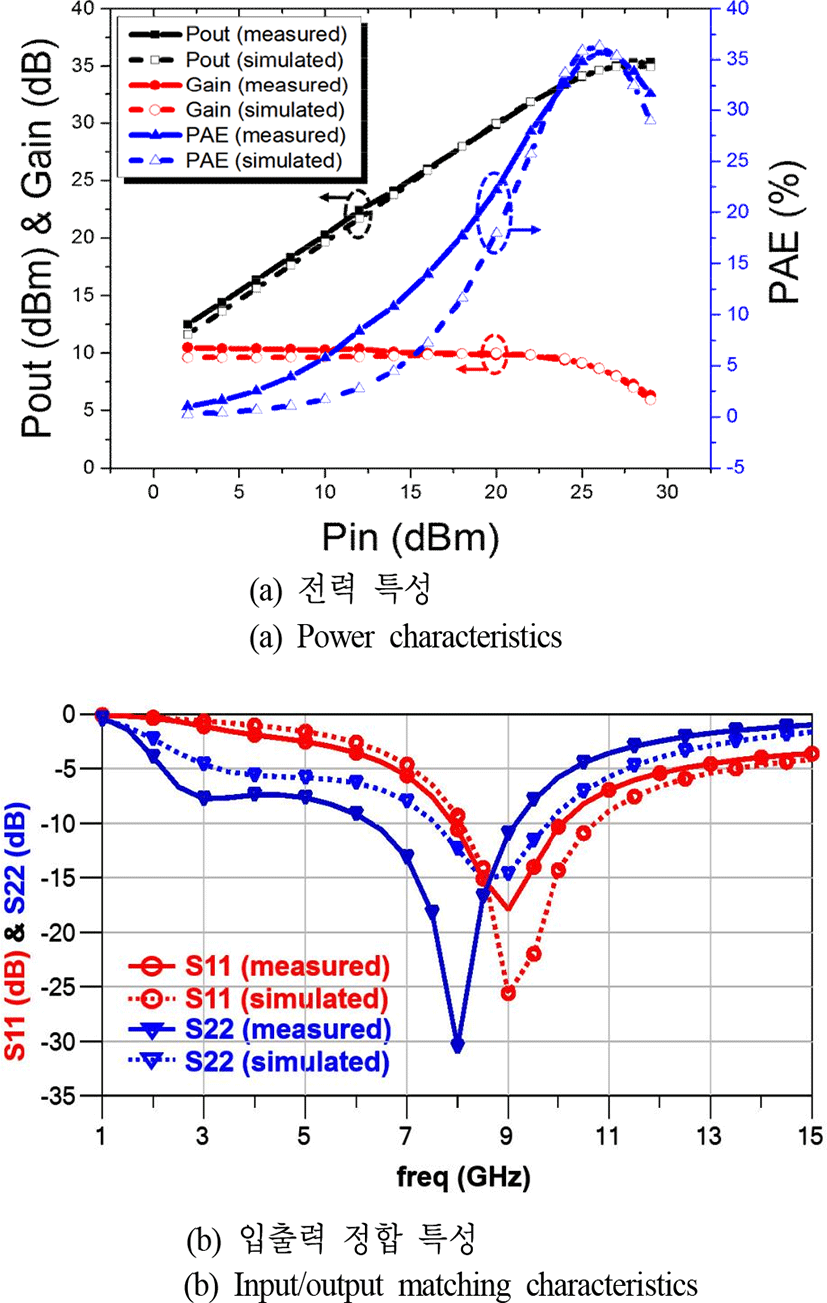
본 논문의 X-대역 3 W GaN 전력증폭기 MMIC 측정 결과를 표 3에 요약하고, 본 논문의 출력전력과 비교적 유사한 최근의 결과들과 비교하였다. 본 논문의 결과는 이득 및 출력전력에서 최근의 결과들과 대체적으로 유사한 성능을 가지며, 기존의 결과들이 효율에서 대체적으로 우수하다. 향후 본 연구진은 GaN MMIC 공정 안정화와 더불어 회로성능 향상을 위한 회로 개발도 병행하고자 한다.
| Ref. | Freq. (GHz) | Gain (dB) | Pout (w) | PAE (%) |
|---|---|---|---|---|
| [9] | 9.5~10.0 | 12.0 | 25.0 | 35.0 |
| [10] | 10.1 | 8.5 | 4.0 | 43.9 |
| [11] | 7.0~14.0 | 6.8~8.0 | >5.0 | >43.0(DE) |
| This work | 9.0 | 10.0 | 3.5 | 35.0 |
Ⅴ. 결 론
본 논문에서는 ETRI 0.25 μm GaN MMIC 공정 및 소자 특성을 소개하였다. ETRI 0.25 μm GaN HEMT 소자를 이용하여 X-대역 3 W GaN 전력증폭기 MMIC 설계하고 제작하여 측정한 결과를 중심으로 논의하였다. ETRI 0.25 μm GaN MMIC 공정 및 소자특성을 평가하고, MMIC 설계 가능성을 검증하기 위하여, GaN 전력증폭기 MMIC를 1단으로 설계하고 제작하였다. X-대역 3 W GaN 전력증폭기 MMIC를 제작하여 평가한 결과, 일부 주파수 하향 천이(shift)가 있었다. 이는 설계에 사용된 모델링 소자와 제작한 MMIC 소자의 문턱전압 천이와 일부 수동소자 특성의 변화에 기인한 것으로 사료되나, MMIC 설계를 위한 ETRI 0.25 μm GaN HEMT 공정은 상당 부분 안정화 단계에 이른 것으로 판단된다.
현재 고주파 및 고출력 MMIC 설계를 위한 ETRI 0.25 μm GaN MMIC 공정 및 소자 안정화를 꾀하고 있으며, 동시에 여러 단의 출력이 필요한 전력증폭기를 설계하여 ETRI 0.25 μm GaN MMIC 공정 평가를 병행하고 있다. 본 논문은 ETRI 0.25 μm GaN MMIC 공정을 이용한 MMIC 제작 결과의 정규논문 최초 보고이며, 이어지는 연구 결과도 다양한 채널을 통해 보고할 예정이다.




















