Ⅰ. 서 론
최근 상용화된 5G 이동통신은 고속 데이터 통신 지원을 위해 새로운 주파수 대역에서 더 넓은 대역폭을 필요로 한다. 국내 이동통신 3사는 5G 서비스를 위해 3.5 GHz 주변 S-대역에서 280 MHz와 28 GHz 주변 Ka-대역에서 2,400 MHz의 주파수 대역폭을 2018년에 할당받았으며, 2019년부터 S-대역을 중심으로 5G 서비스를 제공하고 있다. 5G 시스템을 활용하여 초광대역 고속 데이터 전송을 위해서는 S-대역뿐만 아니라, Ka-대역의 적극적인 활용이 필요하다. 이를 위해서는 경제적이고 성능이 우수한 Ka-대역용 RF(radio frequency) 반도체 부품의 개발이 필요하다.
반도체 패키지 중 QFN(quad flat no-lead) 패키지는 4개의 방향으로 연결되는 Lead-frame과 패키지 아랫면에 패드를 배치하여 집적도를 높이고 실장면적을 줄인 구조로서 소형화, 저비용, 고성능이 가능하여 RF 부품의 패키지에 다양하게 활용되고 있다. QFN 패키지 내의 Lead-frame 패드와 MMIC(monolithic microwave integrate circuits) 다이의 패드를 연결하기 위해 와이어 본딩(wire bonding) 기법, 플립-칩 본딩(flip-chip bonding) 기법, TAB(tape automated bonding) 기법이 있다. 패키지와 MMIC 칩의 접속 기술은 고주파 대역에서 QFN 패키지의 시스템 전체 성능에 영향을 미치는 핵심적인 요소라고 할 수 있다[1],[2]. 다양한 기법 중 와이어 본딩 방식이 가장 일반적으로 사용되고 있으며, 다양한 재료의 와이어에 대한 성능 검증 및 연구가 활발히 진행되고 있다[3]~[5].
반도체 패키지의 본딩 와이어는 낮은 주파수 대역에서 이상적인 전송선로로 동작하지만, 전송 신호의 주파수가 증가함에 따라 기생 리액턴스 성분이 증가하게 되어 RF 신호의 전송 특성에 큰 영향을 미치게 된다. 따라서 Ka-대역 QFN 패키지 기반의 5G RF 부품 개발을 위해서는 QFN 패키지 내의 본딩 와이어의 전기적 특성을 정확하게 분석하여 모델링하고, 이를 기반으로 원하는 RF 특성을 얻을 수 있는 본딩 와이어 설계 기법에 대한 연구가 필요하다.
본딩 와이어의 특성 분석 및 설계를 위해 참고문헌 [5]에서는 주파수 종속 저항(Rskinfm)을 사용하여 더블-π형 본딩 와이어 모델을 제시하고, 두 종류의 물질(알루미늄/금)에 대한 와이어 길이의 변화에 따른 연구를 진행하였다. 추출된 본딩 와이어의 등가회로 모델의 파라미터를 표시하고, S-파라미터를 통해서 본딩 와이어의 R, L, C 기생성분을 검증하였다. 또한, 참고문헌 [6]에서는 본딩 와이어의 EM 구조 모델을 이용해 와이어의 지름, 높이 등을 설계하고, RF 회로 이론 기반으로 시뮬레이션한 S-파라미터를 통해서 등가회로 모델을 제시하고 검증하였다. 참고문헌 [7]에서는 칩과 패키지 사이의 다양한 본딩 와이어에서 와이어의 길이를 변화와 임피던스 부정합이 발생할 때 RF 특성을 연구하였다. 하지만, 위의 연구들은 K-대역 이하 주파수에 대한 연구로, 5G 이동통신 주파수인 Ka-대역에 적합하지 않고, 패키지의 구조를 포함한 분석을 진행하지 않았다.
따라서 본 논문에서는 Ka-대역에서 본딩 와이어의 길이, 개수에 따른 와이어간 상호 인덕턴스를 고려한 등가 모델을 제안하고, 3차원 EM 시뮬레이션을 통해서 본딩 와이어의 인덕턴스 및 결합계수를 예측하고, 이를 도출한 본딩 와이어를 설계하였다. 설계된 본딩 와이어를 7×7 mm 24-Pin QFN 패키지에 적용하여 제작하고, Ka-대역에서의 S-파라미터 특성을 검증하였다. 본 논문의 구성은 다음과 같다.
2장에서는 QFN 패키지 본딩 와이어의 모델링 방법을 제시하고, 3장에서는 Ka-대역용 QFN 패키지에 적용하기 위한 본딩 와이어를 설계하고 모의실험을 진행하였다. 4장에서는 QFN 패키지를 제작하고 실험 및 결과를 제시하고, 5장에서는 결론을 맺는다.
Ⅱ. QFN 패키지의 본딩 와이어 모델링
본딩 와이어의 저항, 커패시턴스 및 인덕턴스의 기생 성분들은 주파수가 증가함에 따라 skin effect로 인해 지속적으로 변화한다[8]. 본 논문에서는 Ka-대역에서 본딩 와이어의 길이, 개수에 따른 와이어간 상호 인덕턴스를 고려한 등가 모델을 제안하고, 3차원 EM 시뮬레이션을 통해서 본딩 와이어의 인덕턴스 및 결합계수를 예측하고, 이를 도출한 본딩 와이어를 설계하였다.
QFN 패키지에서 본딩 와이어에 의한 특성을 분석하기 위하여 그림 1과 같이 MMIC와 패키지의 Lead-frame을 와이어로 연결하는 구조를 고려한다.
그림 1에서의 본딩 와이어에 사용되는 금 와이어를 분석하기 위해 단일 와이어의 기하학적 구조를 그림 2에 도시하였다.

그림 2에서는 Lead-frame과 MMIC 서브스트레이트 간의 세 개의 부분으로 구성된 단일 본딩 와이어의 구조를 제시한다. a는 와이어의 직경, H1은 와이어의 높이, dp는 두 서브스트레이트 간의 수평거리, ɛL,ɛM 은 두 서브스트레이트의 유전율이다. 그림 2의 단일 본딩 와이어는 저항과 직렬로 연결된 집중 인덕턴스의 등가회로를 그림 3과 같이 도시할 수 있다.

그림 3에서 본딩 와이어는 고 충실도 모델(high fidelity model) 기법을 통해서 전송선로처럼 계산할 수 있다[9]. 이 기법을 적용한 본딩 와이어의 유전체에 대한 임피던스와 와이어의 유효 유전 상수를 Zim, xeff로 표시하였다. 그림 3에서 본딩 와이어의 자체 인덕턴스는 Lw, 저항은 Rw로 표시한다.
본딩 와이어는 (H1, D1, D2) 세 부분으로 구성되고, 와이어 길이는 DL로 표시한다. 진공에서 빛의 속도는 v0로 표시되고 도전율은 σ, 단면 면적은 A으로 제시되었다. CL,CM은 와이어와 서브스트레이트 사이에서 발생된 커패시턴스이다. Lead-frame과 MMIC의 두 서브스트레이트의 유전율이 다르기 때문에, 각각 유효 유전상수를 xL과 xM으로 표시한다.
Ka-대역에서의 단일 본딩 와이어의 자체 인덕턴스, 저항 및 커패시턴스 성분을 식 (1)~식 (4)를 활용하여 계산 및 분석할 수 있다. 제안된 단일 본딩 와이어의 파라미터를 표 1에 정리하였다.
Ka-대역의 등가회로 모델을 그림 4와 같이 제시하였다. i번째 와이어의 인덕턴스 성분을 Lwi 로 표시한다. 와이어의 개수가 증가함에 따라 와이어 간의 상호 인덕턴스(M)와 커플링 계수를 고려하여 DL/ds ≫ 1일 때에 식 (5)와 같이 나타낼 수 있다[10]. i번째 와이어와 j번째 와이어 간의 커플링 계수(kij)로 표시하여 i,j=1, 2, 3으로 제시하였다. 자기 상수는 μ0로 표시하고, 와이어간 중심 거리는 ds로 제시하였다.
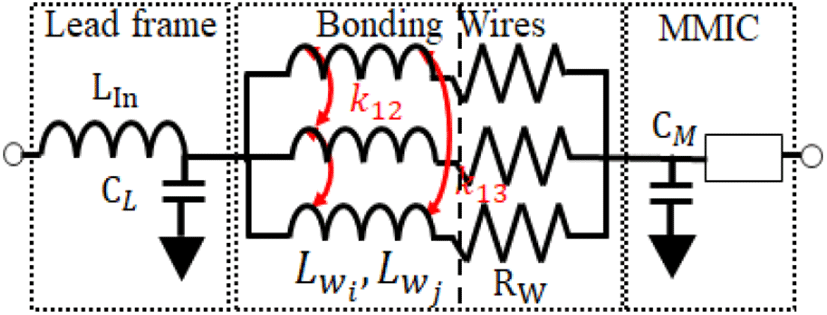
그림 4에서 패키지의 Lead-frame Via에서 발생하는 인덕턴스를 LIn으로 제시하고, 본딩 와이어와 Lead-frame 사이에서 발생한 커패시턴스를 CL, MMIC 사이에서 발생한 커패시턴스를 CM으로 표시하였다.
제안된 본딩 와이어의 길이(DL)는 0.438 mm이고, 개수가 3개인 경우에 대해 도출한 본딩 와이어의 성분들을 단일 본딩 와이어에 적용하여 파라미터 값들을 얻었다. CL이 35.26 f F, Lw는 0.29 nH, Rw는 0.0215 Ω, CM은 119.6 fF이고, 와이어의 간에 커플링 계수인 k12는 0.92, k13은 0.72로 확인되었다. 29 GHz에서의 본딩 와이어 등가회로의 파라미터를 표 2에 도시하였다.
| Parameter of bonding wire circuit model @29 GHz | |||||
|---|---|---|---|---|---|
| LIn | CL | Lw | Rw | CM | |
| 0.455 nH | 35.26 nH | 0.29 nH | 0.0215 Ω | 119.6 nH | |
| k 12 | k 13 | ds | |||
| 0.92 | 0.72 | 0.05 mm | |||
Ⅲ. 본딩 와이어 시뮬레이션 및 분석
7×7 mm 24-pin QFN 패키지의 3D 모델은 그림 5(a)와 같다. 그림 5(b)에 제시된 패키지의 파라미터와 같이 패키지의 신호 Lead-frame 폭은 0.22 mm이고, 양쪽 간격은 0.77 mm이다. 그림 5(c)는 QFN 패키지의 단면도로, 본딩 와이어는 MMIC와 신호 Lead-frame을 연결한다.
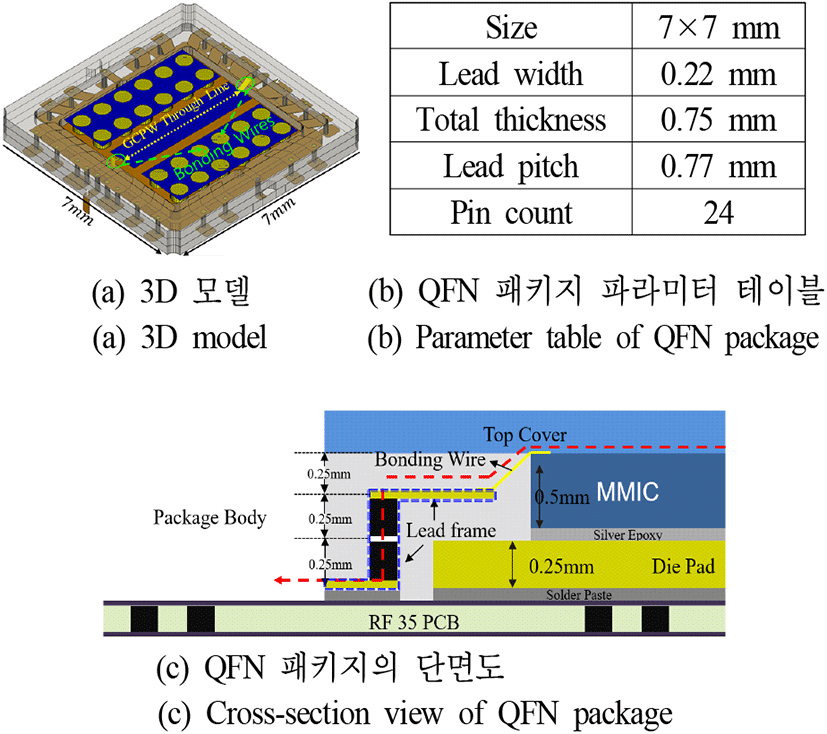
그림 6(a)와 같이, QFN 패키지의 Lead-frame to bonding wire to MMIC EM 3D 모델에서 와이어의 개수(Nk) 및 길이(DL)는 등가회로 모델과 같은 값으로 설계되었다. Ka-대역에서의 QFN 패키지 본딩 와이어 특성의 검증을 위해 MMIC 칩을 GCPW(ground coplanar wave guide) through 선로로 대체하였고, 설계된 QFN 패키지의 측면도를 그림 6(b)에서 제시하였다. 표 2에서 설계한 본딩 와이어가 3개인 등가회로 모델의 모의실험과 그림 6에서 Cadence 사의 AWR EM 시뮬레이션 결과를 그림 7과 같이 비교하였다.
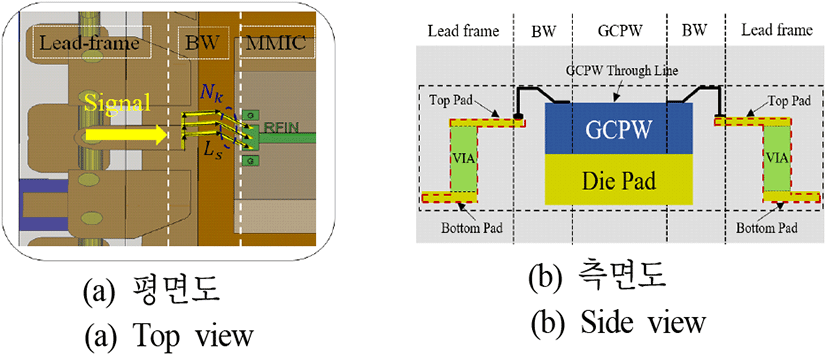

그림 6(a)에서 와이어의 길이(DL)를 438μm로 고정시키고, 본딩 와이어의 개수를 1개부터 8개까지 1개씩 증가시키면서 진행한 EM 시뮬레이션의 S-파라미터 결과를 그림 8에 도시하였다.

그림 8과 같이 S11의 공진 주파수는 와이어의 개수를 1개부터 6개까지 증가시킴에 따라 0.9 GHz, 0.1 GHz, 0.37 GHz, 0.15 GHz, 0.49 GHz만큼 증가하였고, 6개부터 8개까지 증가시킴에 따라 와이어 간의 과도결합으로 인해 0.33 GHz, 0.07 GHz만큼 감소하였다. 와이어 개수에 따른 시뮬레이션 결과를 표 3과 같이 제시하였다.
위의 시뮬레이션 결과를 바탕으로 와이어의 개수를 6개로 설계하고 와이어의 길이(DL)를 변화시키면서 진행한 시뮬레이션의 결과를 그림 9에 제시하였다. 와이어의 길이가 238 μm, 48 μm 만큼 감소함에 따라, 와이어의 병렬 저항과 자체 인덕턴스 성분이 감소하여 공진 주파수가 1.75 GHz, 0.95 GHz 만큼 변화하였다. 와이어 길이에 따른 QFN 패키지 시뮬레이션 결과를 표 4에 정리했다. 와이어 길이와 개수에 따른 시뮬레이션의 스미스 차트 결과는 그림 10에서 제시하였다.


| Ka-band QFN package simulation of wire length | ||||
|---|---|---|---|---|
| Nk | DL | S 11 | S 21 | Resonance frequency |
| 6 | 724 μm | −1.9 dB | −8.1 dB | 31.5 GHz |
| 486 μm | −9.2 dB | −2.2 dB | 29.7 GHz | |
| 438 μm | −22 dB | −1.5 dB | 28.8 GHz | |
Ⅳ. Ka-대역 QFN 패키지 본딩 와이어의 설계 및 실험
다층 HTCC(high temperature co-fired ceramic) 공정으로 제작된 24-pin 7×7 mm QFN 패키지를 그림 11(a)와 같이 제시하였다. 디자인된 QFN 패키지의 신호 패드를 와이어 본딩 방식으로 연결한 구조는 그림 11(b)와 같다.
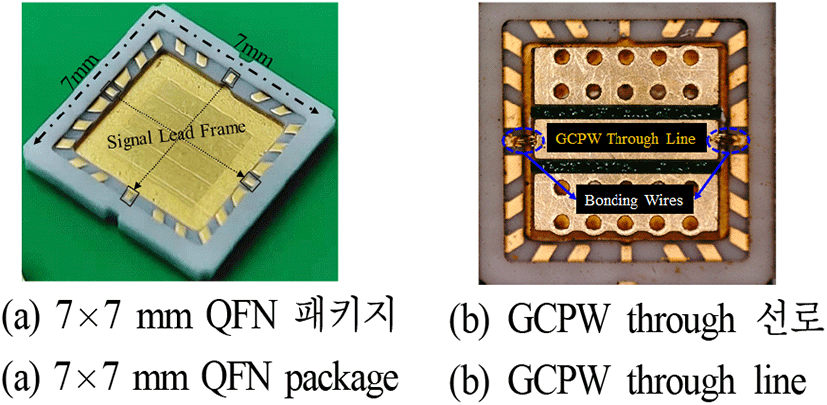
QFN 패키지 본딩 와이어의 특성을 분석하기 위해 그림 12와 같은 측정 환경을 구성하여 GCPW 선로를 설계하였고, MMIC를 GCPW through 선로로 대체하였다. S-파라미터를 분석하기 위해 Keysight 사의 P5007A 벡터 네트워크 분석기를 사용하였다.
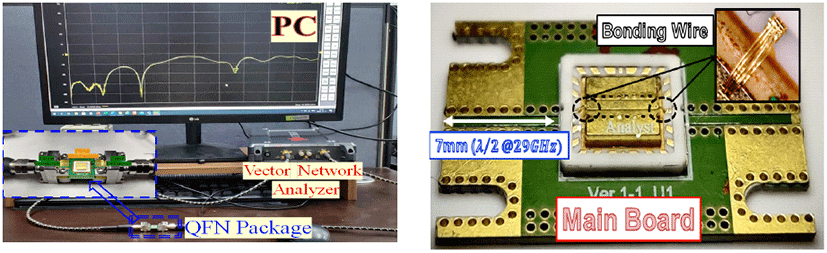
RF 35 Main Board를 바탕으로 한 Ka-대역 QFN 패키지에서 길이(DL)는 426 μm로 고정하고, 개수(Nk)를 3, 6, 10으로 변화시키며 실험을 진행하였다. 그림 13은 실측과 등가회로 모델링한 QFN 패키지의S11(반사 손실), S21(삽입 손실)에 대한 그래프이다. 본딩 와이어의 개수를 3개에서 6개로 변화할 때는 패키지의 공진 주파수가 증가하지만, 10개 경우는 공진 주파수가 감소하였다. 따라서 본딩 와이어의 개수가 6개 이상이면, 와이어 간의 과도결합이 발생하여 공진 주파수가 감소하고, 삽입 손실이 증가한 것을 등가회로 모델 결과를 통해서 검증할 수 있다.

표 5에서의 측정 결과를 기반으로 Nk가 6개일 때의 본딩 와이어 길이에 따른 실험을 진행하였다. Ka-대역 QFN 패키지 본딩 와이어의 29 GHz에서 RF 특성을 검증하기 위해 제안된 본딩 와이어 길이는 GCPW through 선로 길이에 따라 결정됨으로써 선로 길이를 3.5 mm, 4.14 mm, 4.32 mm로 설계 및 제작하였다.
| Ka-band @29 GHz | Nk | DL | S 11 | S 21 |
| 3 | 426 μm | −5.8 dB | −4.4 dB | |
| 6 | −5.4 dB | −4.7 dB | ||
| 10 | −5.2 dB | −4.3 dB |
그림 14에서 본딩 와이어 길이는 패키지의 정합 위치 및 삽입 손실에 영향을 미치는 것을 볼 수 있다. 본딩 와이어의 길이는 GCPW through 선로의 길이가 증가함에 따라 감소한다. 따라서, 와이어의 길이를 438 μm, 486 μm, 724 μm로 설계하여 제작 및 실측하였다.

QFN 패키지의 S-파라미터는 표 6과 같이 본딩 와이어 길이가 438 μm 일 때, 29 GHz 대역에서 S11가 −26 dB, S21이 −1.8 dB로 실측된다. 와이어 길이가 짧아지면서 자체 인덕턴스 성분 및 기생 저항 성분이 작아지므로 삽입 손실이 1 dB 개선됨을 확인하였다.
| Ka-band @29 GHz | Nk | DL | S 11 | S 21 |
| 6 | 438 μm | −24.8 dB | −1.8 dB | |
| 486 μm | −10.4 dB | −3.0 dB | ||
| 724 μm | −8.9 dB | −3.5 dB |
Ⅴ. 결 론
본 논문에서는 GCPW through 선로와 QFN 패키지 Lead-frame 간의 다중 본딩 와이어 트랜지션의 방식에 대해 RF 특성 검증 기법 및 패키지 3D EM 시뮬레이션 과정을 제시하였다.
Ka-대역 본딩 와이어의 등가 모델링을 제시하고, 와이어의 개수 및 길이 변화에 따른 특성을 모의실험과 실측 결과를 통해 검증하였다. 438 μm인 단일 및 다중 본딩 와이어의 기생 성분을 기하학적 접근법과 등가회로 모델을 통해서 도출하였고, EM 시뮬레이션 결과와 비교하여 확인하였다. 본 연구는 5G용 QFN 패키지에서 MMIC와 패키지의 본딩 와이어 연결 구조 설계 및 특성을 분석에 활용될 수 있을 것으로 기대된다.




