Ⅰ. 서 론
내부에 잡음이 있는 2-포트 회로망의 표현방법으로는 내부의 잡음원을 입력 포트에 등가적인 직렬 전압원과 병렬 전류원으로 나타내는 방법[1],[2]과 각 포트에서 발생하는 잡음파(noise wave)로 표현하는 방법[3]~[6]이 있다. 잡음파를 이용한 2-포트 회로망의 잡음 표현은 그림 1과 같이 각 포트로 잡음파 c1과 c2가 나타나는 형태로 표현된다[4]~[6].
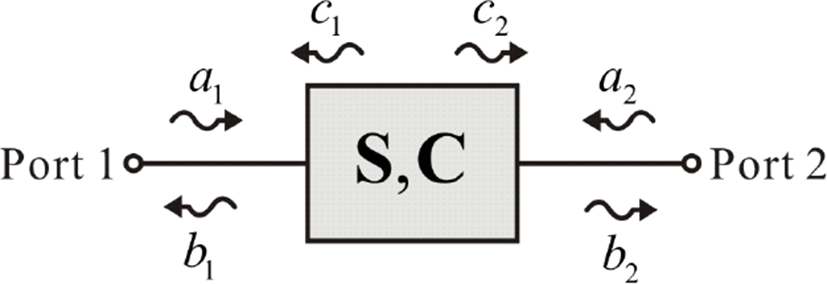
그림 1의 잡음파 c1과 c2는 시변 복소 확률변수(time-varying complex random variables)이며, 서로 상관관계를 가지고 있다. 각 잡음파들의 잡음전력 |c1|2과 |c2|2이 에르고딕(ergodicity)하다고 가정하고, c1과 c2의 상관관계가 광의의 결합 정상적 프로세스(jointly wide-sense stationary processes)라고 가정하면, 이 두 잡음파는 시간평균의 값으로 결정될 수 있다. 이와 같은 정의를 기초하여, 그림 1의 출력파 b1과 b2는 식 (1)과 같이 S-파라미터와 입사파 a1, a2 그리고 잡음파 c1과 c2가 중첩(superposition)이 된 결과로 표현할 수 있다. 여기서 sij는 2-포트 회로망의 S-파라미터 성분을 나타낸다.
식 (1)의 잡음파에 대한 잡음상관행렬(noise wave correlation matrix: NWCM)은 식 (2)와 같이 계산된다.
식 (2)에서 오버 바(over bar)는 시간평균을 나타내며, 대거(dagger)는 켤레복소수(complex conjugate)의 전치를 나타낸다. 그리고 *는 켤레복소수를 나타낸다. 식 (2)는 kTo 로 정규화된 NWCM이며, k는 볼츠만 상수(Boltzmann constant)이며, To는 290 K이다. 식 (2)의 행렬에서 대각 항들인 c11과 c22는 각 잡음파 c1과 c2의 크기를 나타내며 실수 값이다. c12와 c12*는 잡음파 c1과 c2의 상관관계를 나타낸다. 그리고 C의 각 항들은 주파수와 대역폭 Δf의 함수이다. 여기서 대역폭 Δf를 1 Hz로 설정하면, NWCM의 각 항들의 값은 잡음전력 스펙트럼 밀도(noise power spectral density)와 같게 된다. 본 논문에서는 1-Hz 대역폭을 가정하여 모든 잡음계산 및 측정된 잡음전력을 표현하였다. 따라서 본 논문에서 언급되는 잡음전력은 잡음전력 스펙트럼 밀도와 동일하게 헤르츠(herz)에 대한 잡음전력을 의미한다. 이 2-포트 소자의 NWCM과 S-파라미터를 알게 되면, 통상적인 잡음 파라미터 NFmin, Rn, Sopt를 잘 알려진 잡음 파라미터 변환을 통해 결정할 수 있게 된다[6]~[8].
이 NWCM에 대한 측정방법은 몇몇 연구자들에 의해 연구된 바 있다[6],[8]~[13]. 참고논문 [6]에서는 2 개의 잡음전원(noise source)과 2 개의 서큘레이터(circulator)와 Thru 그리고 3 dB 하이브리드(hybrid) 커플러(coupler)를 이용한 측정구성을 통해 NWCM 측정방법을 보인 바 있다. 그리고 참고문헌 [8]~참고문헌 [11]에서는 6-포트 회로망을 이용한 NWCM 측정방법을 보인 바 있다. 하지만 이 방법들은 절대적인 잡음전력(absolute noise power) 측정에 의존한다. 잡음지수분석기(noise figure analyzer: NFA) 또는 스펙트럼 분석기와 같은 잡음측정 장비로 측정된 절대 잡음전력은 측정 장비에 의한 불규칙 리플(ripple)을 포함하고 있다. 따라서 이 측정된 잡음전력으로 계산된 NWCM은 이 불규칙 리플이 동반된 결과를 보이게 되며, 이로 인해 측정된 NWCM의 부정확성이 증가하게 된다.
참고문헌 [12], 참고문헌 [13]에서는 측정된 잡음전력의 잡음전력비(noise power ratio)를 이용, 측정된 잡음전력에서 나타나는 불규칙 리플이 최소화할 수 있는 NWCM 측정방법을 보였다. 이 논문들에서는 잡음전력비를 이용, 동축 커넥터로 구성된 동축형(coaxial type) DUT의 NWCM만을 측정하였다. 하지만 최근에는 칩(chip) 소자의 응용이 늘어가는 추세이며, 이에 따라 칩 소자의 잡음 파라미터 평가가 더욱 중요해지고 있는 상황이다[14]~[17].
잡음 측정 시에 사용하는 입력 터미네이션들은 동축형이다. 따라서 참고문헌 [8]~ 참고문헌 [13]에서 동축형 DUT 측정 시, 입력 터미네이션들은 동축형 DUT에 직접 연결이 된다. 즉, 그림 2(a)의 참고논문 [13]의 측정구성에서 Γx로 정의된다. 이 Γx로부터 무잡음(noiseless) 50-Ω에 전달되는 잡음전력은 네트워크 분석기를 이용한 1-포트 S-파라미터 측정결과를 통해 쉽게 결정될 수 있다. 하지만 칩 DUT의 측정 시에는 그림 2(b)와 같이 Γx와 칩 DUT 사이에 바이어스-티와 프로브 등이 추가되게 된다. 따라서 칩 DUT에 대한 잡음 측정 시에는 Γx로 정의된 입력 터미네이션(termination)을 Γg,x로 재정의해야 한다. 입력 터미네이션을 Γg,x로 정의하기 위해서는 그림 2(b)에 표시된 어댑터(adapter)의 S-파라미터 측정이 필요하다. 하지만 이 어댑터는 프로브와 open으로 종단된 선로를 포함하고 있어, 네트워크 분석기를 이용한 일반적인 측정방법을 통해 측정할 수 없다. 따라서 본 논문에서는 1-포트 측정을 이용하여 2-포트 S-파라미터를 결정하는 방법을 활용, 어댑터의 2-포트 S-파라미터를 측정하는 방법을 보였다. 그리고 이 측정된 어댑터의 S-파라미터를 통해 Γg,x를 정의하고, 이 Γg,x로부터 무잡음 50-Ω에 전달되는 잡음전력을 결정하는 방법 또한 보였다.
본 논문에서는 칩 DUT의 잡음 측정을 위한 입력 터미네이션의 정의방법을 제안하며, 이 제안된 방법으로 정의된 새로운 입력 터미네이션과 참고문헌 [13]의 잡음전력비에 기초한 NWCM 측정방법 이용, 온-웨이퍼형(on-wafer type) DUT의 NWCM을 측정하였다. 측정 시의 측정구성은 그림 2(b)와 동일하다. 이 측정구성은 그림 2(a) 에 보인 참고문헌 [13]의 측정구성에 온-웨이퍼형 DUT를 측정하기 위한 웨이퍼 프로브(wafer probe)와 DUT에 바이어스(bias)를 인가하기 위한 바이어스-티(bias-tee)가 추가된 것이다.
제안된 방법을 통해 1.5 dB의 잡음지수 성능을 갖는 LNA 칩에 대해 NWCM을 측정하였고, 측정된 NWCM을 통해 칩의 잡음 파라미터 결과를 얻었다. 측정을 통해 결정된 칩의 잡음 파라미터 결과는 칩의 데이터시트에 있는 결과와 유사한 결과를 보였다.
Ⅱ. 온-웨이퍼형 DUT의 NWCM 측정구성
온-웨이퍼형 DUT는 웨이퍼 프로브를 이용하여 측정 가능한 형태의 DUT로 다이(die)형 칩 또는 다이형 칩이 패키지(package)된 칩을 말한다. 다이(die)형 칩(chip)은 프로브를 이용하여 직접 측정이 가능하지만, 패키지(package)된 칩은 측정용 기판에 실장되어 측정된다.
본 논문에서는 패키지된 칩을 이용하였고, 본 논문의 온-웨이퍼형 DUT 구성을 그림 3에 보였다. 그림 3의 구성은 프로브를 연결하기 위한 프로브 패드와 마이크로스트립 선로(microstrip line)로 이루어진 기판에 칩이 실장된 형태 이다. 프로브 패드는 CPWG(Coplanar Waveguide with lower Ground plane) 구조로 설계되었다. 여기서 주목할 점은 이 온-웨이퍼형 DUT를 통해 측정되는 NWCM은 칩만의 NWCM이라는 점이다.
그림 2(b)의 측정구성을 통해 그림 3의 온-웨이퍼형 DUT를 측정하게 된다. 그림 2(b)의 측정구성에서 잡음측정 장비는 Keysight사의 N8975A를 사용하였고, 수신기(receiver)에 사용된 저잡음증폭기(low noise amplifier: LNA)는 Wenteq사의 ABL1800-03-2825모델로 이득은 약 30 dB, 잡음지수는 약 3 dB의 성능을 갖고 있다. 감쇠기(attenuator)는 Mini-circuits사의 제품을 이용하였고, 감쇠는 약 13 dB이다. 그리고 프로브는 GGB사의 40A-1000 pitch 모델을 이용하였다. 바이어스-티는 Aero-flex사의 8810KMF2-26 모델을 이용하였다. 입력 터미네이션(termination)으로 사용된 잡음전원은 Keysight사의 N4002A 모델이고, open, short, offset short은 85052D 교정 세트(calibration kit)를 이용하여 구현되었다. 여기서 전치-증폭기(pre-amplifier)는 NFA의 잡음영향을 최소화하고, DUT의 잡음전력을 증폭하는 역할을 한다.
그림 2(b)에서 어댑터-1이 포함된 터미네이션들의 Γg,x로부터 무잡음(noiseless) 50-Ω에 전달되는 잡음전력을 결정하고, 어댑터-2가 포함된 전치-증폭기 즉, 그림 2(b)에 표시된 수신기의 S-파라미터를 결정하게 되면, 칩만의 NWCM을 측정할 수 있게 된다. 이 Γg,x로부터의 잡음전력과 수신기의 S-파라미터는 그림 2(b)에 표시된 어댑터들의 S-파라미터를 알면 가능하게 된다. 이 어댑터의 S-파라미터 측정방법은 서론에서 언급한 바와 같이 별도의 S-파라미터 측정방법을 필요하며, 이에 대한 내용은 Ⅲ장에 설명하였다. 그리고 어댑터의 S-파라미터를 알았을 때, Γg,x로부터 무잡음(noiseless) 50-Ω에 전달되는 잡음전력을 결정하는 방법 또한 Ⅲ장에 설명하였다.
Γg,x로부터 전달되는 잡음전력이 정의되고, 수신기의 S-파라미터를 결정하면, 다음과 같은 측정과정을 통해 칩만의 NWCM을 결정할 수 있게 된다. 우선 그림 2(b)의 P3 기준면에서 잡음전원을 이용 NFA를 교정한다. 그 다음, 칩이 없는 thru 선로만으로 구성된 기판을 이용, 그림 2(b)의 P2 기준면에 Γg,x가 연결되었을 때의 잡음전력비 4개를 측정한다. 이 측정된 4개의 잡음전력비와 참고문헌 [13]의 수식을 이용하면, 수신기의 NWCM CB를 결정할 수 있게 된다. CB를 결정한 후 측정 기판을 그림 3의 온-웨이퍼형 DUT로 교체하여 측정하면, 그림 2(b)의 P1 기준면에 Γg,x가 연결되었을 때의 잡음전력비 4개가 측정된다. 이 측정된 4개의 잡음전력비를 통해 칩과 수신기가 결합된 구조의 NWCM CC를 결정할 수 있다. 이 결정된 NWCM CC에서 NWCM CB를 NWCM의 디-임베딩(de-embedding) 과정[12],[13]을 통해 디-임베딩하면 칩만의 NWCM을 구할 수 있게 된다. 결정된 칩만의 NWCM에 대한 변환과정을 통해 칩의 잡음 파라미터 결과를 얻을 수 있게 된다. 이 측정과정에서는 칩만의 S-파라미터가 필요하게 되는데, 이는 그림 3의 측정구성에 대한 S-파라미터 측정결과에 TRL 교정[18]을 적용하면 결정할 수 있게 된다.
Ⅲ. Adapter의 S-파라미터 측정
어댑터들은 바이어스-티와 프로브 그리고 open으로 종단된 선로로 구성되어 있다. 여기서 바이어스-티는 입출력포트가 동축 형태로, 네트워크 분석기의 일반적인 2-포트 측정을 통해 결정될 수 있다. 하지만 그림 4에 보인 프로브와 open으로 종단된 선로가 결합된 구조는 포트 1은 동축 커넥터로 되어 있고, 포트 2는 open된 선로 형태이다. 따라서 이 구조는 일반적인 2-포트 S-파라미터 측정을 통해 S-파라미터를 결정할 수 없다.
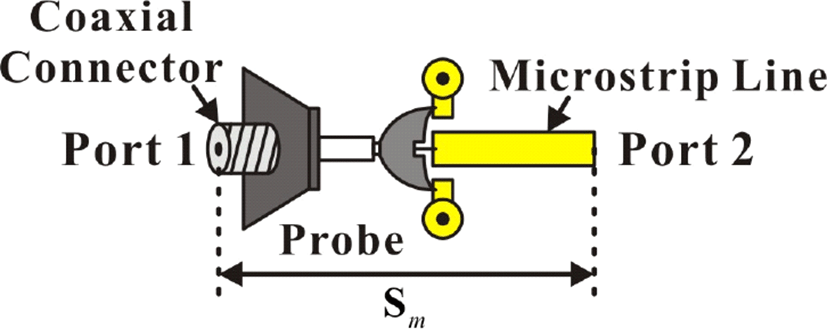
본 논문에서는 그림 4의 구조에 대한 2-포트 S-파라미터 측정방법으로, 1-포트 측정을 통해 2-포트 S-파라미터를 결정하는 방법[19]을 사용하였고, 이 방법의 측정구성은 그림 5와 같다.

그림 5에서 프로브의 동축 커넥터를 기준으로(그림 5 의 Ref.), 프로브가 open, short, 50-Ω으로 종단된 선로에 각각 연결되었을 때, 측정되는 3개의 S-파라미터 s11,o, s11,s, s11,t는 식 (3)으로 표현할 수 있다.
여기서 sijm은 그림 4의 Sm에 대한 성분을 의미하며, ΓL,x는 부하 open, short, 50-Ω의 반사계수이다. 식 (3)을 s11m, s22m, s21ms12m을 미지수로 식을 풀게 되면 식 (4)의 결과를 얻을 수 있게 된다.
여기서 Δ, Δ1, Δ2, Δ3는 식 (5)와 같다.
식 (4)와 식 (5)에서 s11,x는 측정을 통해 이미 결정된 값이고, 부하들에 대한 반사계수 ΓL,x를 알면, Sm을 결정할 수 있다. 이 부하들의 반사계수 ΓL,x는 TRL 교정의 계산과정을 통해 결정된다[18]. 즉, TRL 교정을 위한 회로를 그림 6과 같이 Thru, Line 그리고 open, short, 50-Ω에 대한 3종의 Reflect로 구성한다. 그리고 Thru, Line과 Reflect 1, Reflect 2, Reflect 3을 1개씩 사용한 총 3번의 TRL 계산과정을 통해 ΓL,x를 결정할 수 있게 된다. 따라서 식 (4)와 식 (5)를 이용, 그림 4의 Sm을 결정할 수 있게 된다.

식 (4)와 식 (5)로 Sm을 결정하는 과정에서 Sm은 수동소자에 대한 S-파라미터이므로 s21m=s12m이 성립한다. 따라서 식 (4c)의 제곱근을 통해 s21m은 결정된다. 이때, s21m의 위상은 정정이 필요한 경우가 발생할 수 있다. 이 경우에는 낮은 주파수에서의 측정 결과를 통해 조정의 필요 여부를 판단할 수 있다. 그리고 선택된 부하 open, short, 50-Ω은 주파수에 상관없이 서로 독립된 임피던스이므로, 식 (4)와 식 (5)의 계산 시에 특이점(singular point)은 발생하지 않는다.
어댑터의 구성품 중 네트워크 분석기의 일반적인 2-포 트 측정으로 측정 가능한 바이어스-티의 s21 측정결과를 그림 7에 보였다. 그림 7의 측정결과를 통해, 본 논문에서 사용된 바이어스-티는 주파수 대역 1-3 GHz에서 약 0.25~0.5 dB의 손실을 갖는 것을 확인할 수 있다.

그 다음, 3-1에 설명된 방법을 이용, 프로브와 선로가 결합된 구조의 S-파라미터를 측정하였고, 측정된 결과를 검증하였다. 측정은 TRL 교정용 기판을 이용하였고, 제작된 TRL 교정용 기판은 그림 8에 보였다. 제작된 기판의 구성은 그림 6의 구성과 거의 동일하다.
그림 8의 제작된 기판을 이용하여, 먼저 Reflect들의 부하에 대한 반사계수를 결정한다. 이 반사계수는 Thru와 Line 그리고 3 개의 Reflect들에 대해 측정된 S-파라미터를 이용한 3 번의 TRL 교정의 계산과정을 통해 얻어지게 된다. 그 다음, 그림 9(a)와 같이 프로브와 선로가 결합된 2개의 구조에 대한 S-파라미터 Sm1과 Sm2를 측정한다. 이들은 3-1에 설명된 것과 같이, 그림 8의 Reflect 회로들에 대한 3개의 1-포트 S-파라미터와 3개의 부하에 대한 반사계수를 통해 결정된다. 그리고 그림 9(b)에 대한 S-파라미터 St를 측정한다. 이 측정은 그림 8의 Thru 회로를 통해 측정된다. 그림 9(b)는 두 개의 프로브로 구성되어, 입출력포트가 모두 동축으로 되어 있으므로, 일반적인 2-포트 S-파라미터 측정을 통해 측정된다.
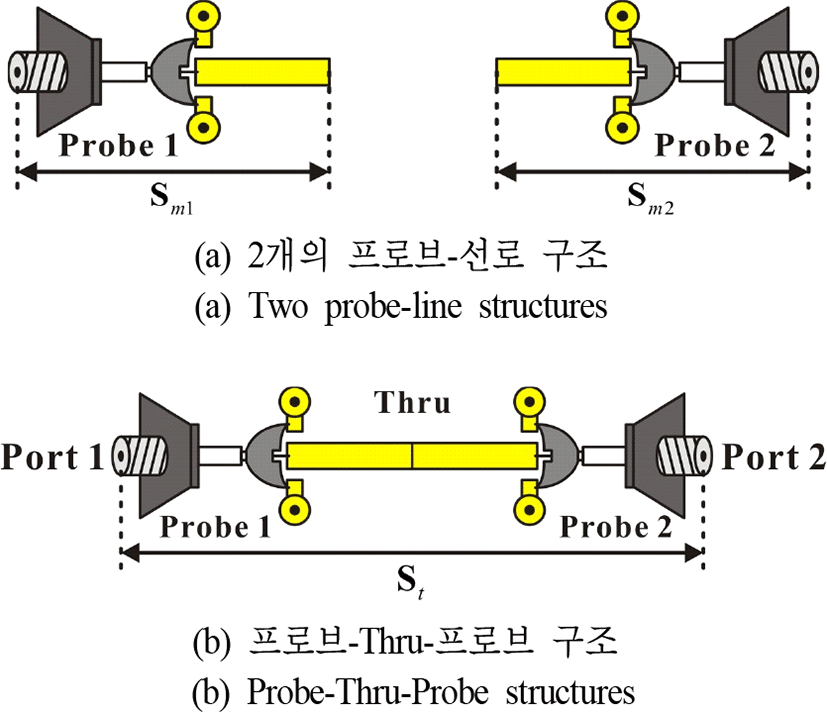
그림 8에서 1-포트에 대한 Reflect 회로의 길이는 Thru 회로의 절반이다. 따라서 그림 9(a)에 대한 두 측정결과를 결합하면, 그림 9(b)의 결과와 같아야 한다. 즉, Sm1 + Sm2 = St를 만족해야 한다. 그림 9(a)의 두 결과를 결합한 S-파라미터와 그림 9(b)의 S-파라미터 측정결과를 그림 10에 보였다. Sm1 + Sm2와 St가 거의 동일한 것을 확인할 수 있다. 이 결과를 통해, 3-1에 보인 방법을 이용하면, 그림 2(b)의 어댑터-1과 어댑터-2에 대한 S-파라미터를 측정할 수 있게 된다.
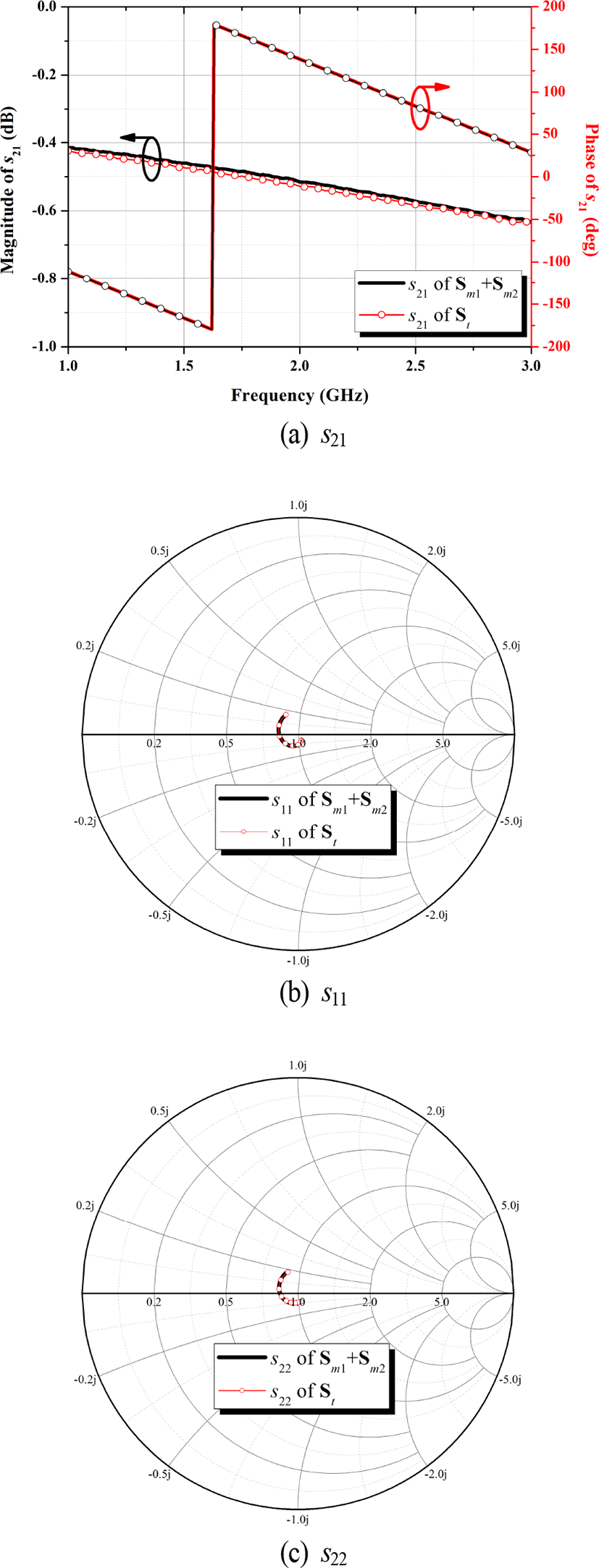
그림 2(b)의 어댑터들의 S-파라미터는 3-1과 3-2에 설명된 내용을 통해 측정된다. 이를 통해, 우선 어댑터-2가 포 함된 수신기의 S-파라미터를 결정할 수 있다.
동축형 터미네이션들의 1-포트 S-파라미터 측정을 통해 결정된 Γx로부터 무잡음 50-Ω에 전달되는 잡음전력 px는 식 (6)으로 계산된다[20],[21]. 식 (6)은 kTo로 정규화되었으며, k는 볼츠만상수(Boltzmann constant)이고, To는 290 K이다.
여기서 Γx는 x가 h, c, o, s, d로 대체될 때, 잡음전원의 hot 상태, cold 상태 그리고 open, short, offset short에 대한 반사계수를 표시한다. 그리고 잡음전원의 cold 상태와 open, short, offset short 터미네이션의 온도는 잡음전원의 온도센서를 통해 NFA에 표시되는 Tcold로 결정되며, 잡음전원의 hot 온도는 Tc와 잡음전원의 ENR 값을 이용한 계산을 통해 결정된다[22].
그림 2(b)의 측정구성에서 칩만의 NWCM을 측정하기 위해서는 Γg,x로부터 무잡음 50-Ω에 전달되는 잡음전력 px’가 필요하다. 이 px’를 알기 위해서는 우선 Γg,x를 결정해야 하며, 이 Γg,x는 Γx와 어댑터-1의 S-파라미터 Sp를 통해 결정된다.
Γg,x를 이용, 어댑터-1이 포함된 cold 상태의 잡음전원과 open, short 그리고 offset short으로부터 무잡음의 50-Ω으로 전달되는 잡음전력 px’는 식 (7)로 결정된다. 식 (7)은 kTo로 정규화되었다.
식 (7)은 cold 상태의 터미네이션들에만 적용 가능한 식이다. 어댑터-1이 포함된 hot 상태의 잡음전원의 경우, 어댑터-1에 의해 생성되는 잡음을 별도로 고려해야 한다. 어댑터는 수동소자이기 때문에 S-파라미터를 이용, 어댑터-1의 NWCM Cp’는 식 (8)로 계산할 수 있다.
식 (8)의 Cp’을 이용, 어댑터-1이 포함된 hot 상태의 잡음전원으로부터 무잡음의 50-Ω으로 전달되는 잡음전력 ph’는 식 (9)로 계산된다. 식 (8a) 또한 kTo로 정규화되었다. 여기서 ph는 식 (6)에서 계산된 값이다.
식 (7)과 식 (9)를 통해, Γg,x로부터 무잡음의 50-Ω으로 전달되는 잡음전력 px’을 결정하였다. 이 px’를 참고문헌 [13]의 잡음전력비를 이용한 측정방법의 수식에 적용하면, 온-웨이퍼형 DUT 측정에 대한 수식을 얻을 수 있게 된다. 이에 대한 수식은 식 (10)~식 (14)에 보였다.
식 (10)의 nx,c는 Γg,c에 대한 출력 잡음전력 nc를 기준으로 Γg,x(x = h, o, s, d)에 대한 출력 잡음전력 nx의 잡음전력비를 의미한다. 이 nx,c는 잡음전력 측정으로부터 결정된 값이다. 그리고 분자의 첫 번째 항은 Γg,x에 의한 DUT의 출력 잡음전력을 나타내며, 이 또한 측정을 통해 결정된 값이다. 미지수 c1과 c2를 포함하는 두 번째 항은 식 (2)의 성분인 c11, c22 및 c12를 사용하여 확장할 수 있다. 분모로 식 (10)의 양변을 곱하고, 측정을 통해 이미 결정된 값과 미지수를 분리하면, 식 (11)의 연립 방정식을 얻을 수 있게 된다.
여기서
식 (12c)에서 rx와 qx는 식 (13a) 및 식 (13b)와 같다.
x = h, o, s, d에 의한 식 (12a)의 yx는 식 (14)와 같다.
식 (11)의 연립 방정식을 풀면, DUT의 NWCM을 구할 수 있다. 이 수식을 이용, 수신기의 NWCM CB와 칩과 수신기가 결합된 구조의 NWCM CC를 구하게 된다. 그리고 이 두 NWCM의 디-임베딩을 통해 칩의 NWCM을 결정할 수 있게 된다.
Ⅳ. 잡음 파라미터 측정
측정에 사용된 LNA 칩은 Broadcom사의 MGA-72543 모델[23]이며, 이 칩을 이용하여 제작된 온-웨이퍼형 DUT를 그림 11에 보였다. MAG-72543 칩은 1-3 GHz의 주파수 범위에서 1.5 dB 정도의 잡음지수 성능을 보인다. 사용된 기판은 Rogers사의 Ro4003C이다.
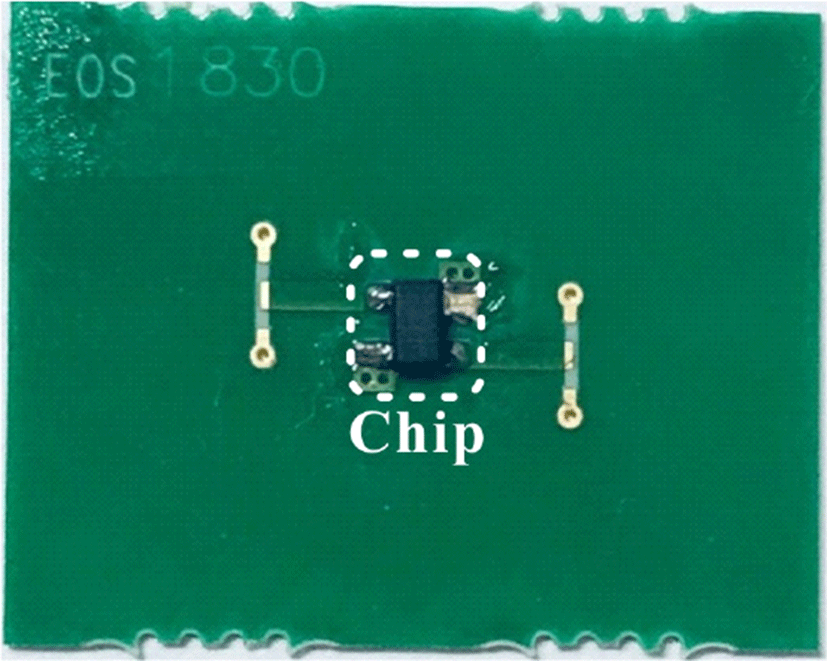
그림 11의 온-웨이퍼형 DUT에 대해 측정된 S-파라미터와 그림 8의 TRL 교정용 기판을 이용한 TRL 교정과정 을 통해 MGA-72543 칩의 S-파라미터는 결정된다. 결정된 MGA-72543 칩의 S-파라미터는 제조사에서 제공하는 S-파라미터와 비교하여 그림 12에 보였다. 그림 12에서 실선은 측정된 S-파라미터를 나타내고, 점선은 제조사에서 제공된 S-파라미터이다. 그림 12(a)의 s21의 결과, 측정된 결과가 전체적으로 0.5 dB 정도 큰 것을 확인할 수 있다. 그리고 그림 12(b)의 s11과 s22의 결과는 측정된 결과가 0.5~1 dB 정도 작게 나온 것을 확인할 수 있다. 하지만 전체적인 결과의 경향은 거의 같은 것을 알 수 있다. 크기에서 차이가 발생한 것은, 데이터시트의 결과는 바이어스-티의 손실이 포함된 칩의 S-파라미터 결과이고[23], 측정된 결과는 TRL 교정을 통한 칩만의 S-파라미터 결과이기 때문이다.
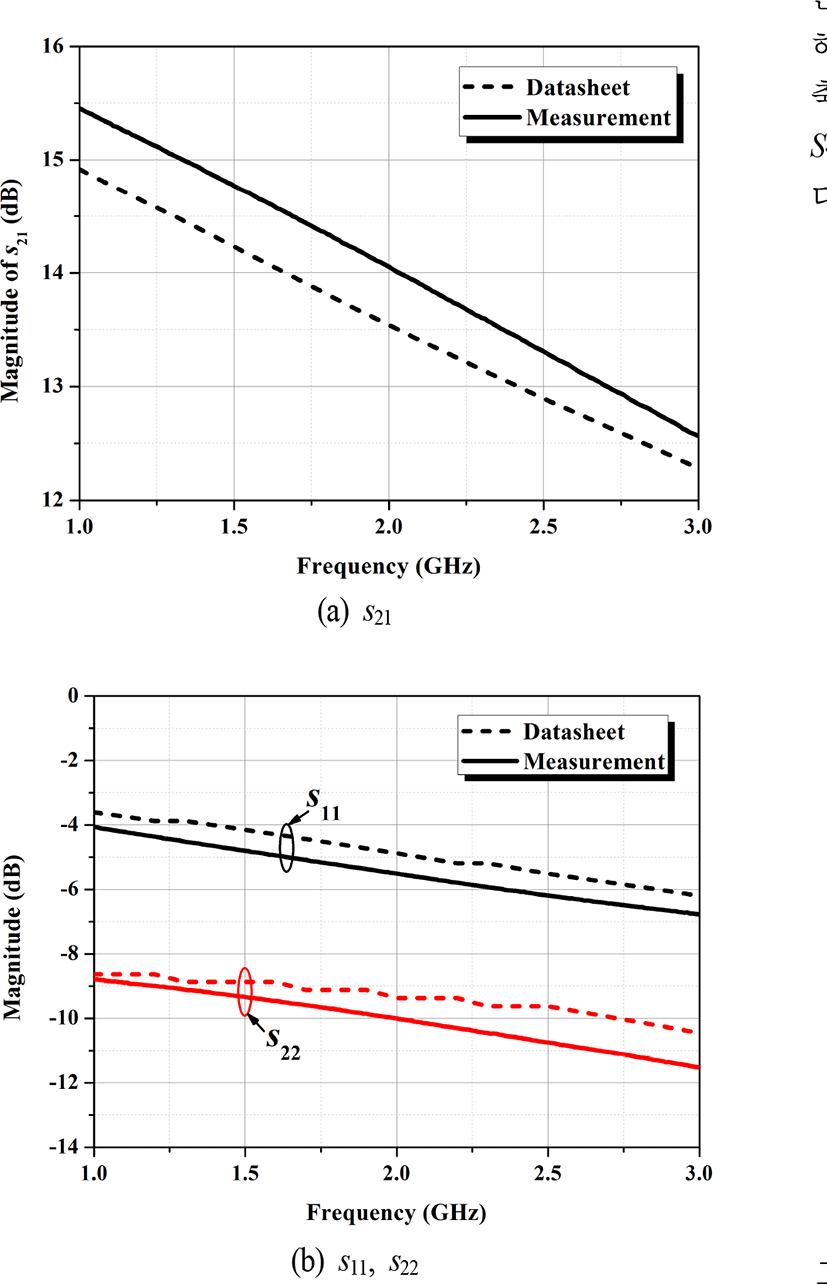
온-웨이퍼형 DUT를 측정하기 위해서는 주변의 통신신호에 의한 간섭을 막기 위한 차폐(shield)가 반드시 필요하다. 하지만 그림 11의 온-웨이퍼형 DUT는 측정 시 프로브를 이용하기 때문에, DUT만을 차폐할 수 없다. 본 논문에서는 이를 해결하기 위해, 은박으로 둘러싼 스티로폼 박스를 제작하여 프로브 스테이션 전체를 차폐시켰다. 이에 대한 장비 구성은 그림 13에 보였다. 그림 13에서 NFA 는 자체적으로 차폐가 되어 있기 때문에 별도로 차폐를 하지 않았다. 그리고 NFA와 박스 내부의 측정구성은 동축 케이블로 연결된다. 추가된 동축 케이블은 일반적인 S-파라미터 측정을 통해 2-포트 S-파라미터가 결정이 된다. 이 동축 케이블은 그림 2(b)의 측정구성에서 수신기에 포함된다.
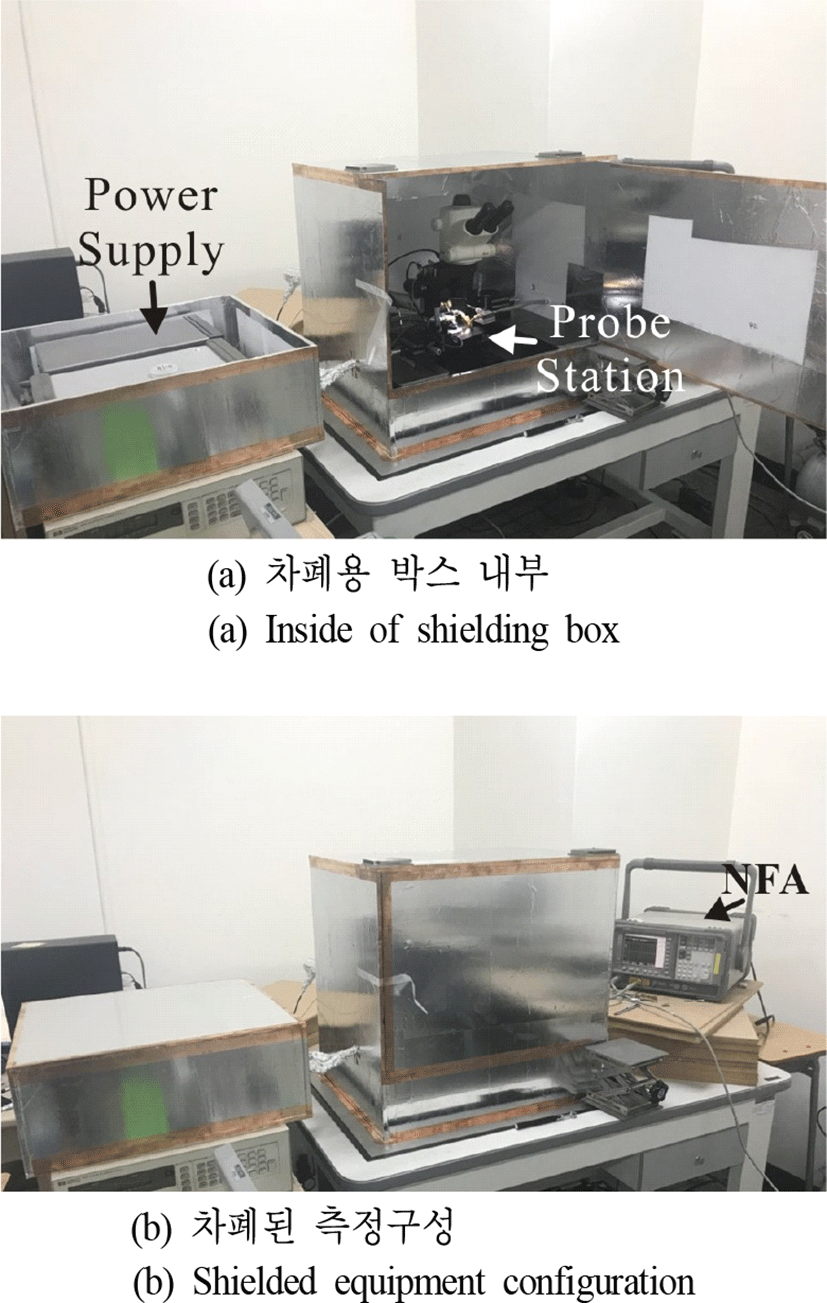
그림 13의 차폐된 장비 구성을 통해 잡음전력비가 측정된다. 수신기의 NWCM은 그림 8에 보인 TRL 기판의 Thru에 대한 잡음전력비 측정을 통해 결정되고, 칩과 수신기가 결합된 구조의 NWCM은 그림 11의 온-웨이퍼형 DUT에 대한 잡음전력비 측정을 통해 결정된다. 그리고 두 NWCM의 디-임베딩을 통해 칩만의 NWCM을 결정된다. 이 결정된 칩의 NWCM을 이용한 변환과정을 통해 칩의 잡음 파라미터를 얻을 수 있게 된다.
이와 같은 과정을 통해 얻어진 MGA-72543 칩의 잡음 파라미터 결과를 그림 14에 보였다. 측정 시, MGA-72543 칩의 바이어스는 드레인 전압 3 V, 드레인 전류는 20 mA이다. 측정결과는 제조사에서 제공하는 잡음 파라미터 결과와 비교하여 보였다. 그림 14에서 실선은 측정된 잡음파라미터 결과이고, 점선은 제조사의 데이터시트에 있는

잡음 파라미터 결과이다. 측정은 총 5번 반복 측정하였고, 5번의 측정결과에 대한 표준편차를 그래프에 막대로 나타내었다. 그림 14(a)에는 NFmin의 측정 결과를 보였다. 측정된 NFmin의 결과는 데이터시트의 결과에 비해 약 0.1 dB 정도 작은 결과를 보였지만, 주파수가 증가함에 따라 증가하는 경향은 유사한 것을 확인할 수 있다. 그림 14(b)에 보인 Rn의 결과는 우선, Rn이 물리적으로 가질 수 있는 최솟값인 Rn,min의 결과[24]보다 큰 것을 확인할 수 있다. 따라서 측정된 MGA-72543 칩의 잡음 파라미터 결과는 물리적으로 타당한 결과이다. 그리고 측정된 Rn의 결과 또한 데이터시트의 값보다 약 1 Ω 정도 작지만, 주파수가 증가함에 따라 감소하는 경향은 유사한 것을 확인할 수 있다. 그림 14(c)에는 Sopt 측정 결과를 스미스차트에 보였고, 그림 14(d)와 그림 14(e)에는 이 측정결과를 크기와 위상으로 보였다. Sopt의 측정결과는 크기가 0.1 정도 작아, 위상변화가 더 크게 발생한 것을 확인할 수 있다.
5번의 반복 측정결과에 대한 표준편차는 그림 14에 막 대 바로 표시하였다. 주파수에 따른 각 잡음 파라미터의 최대 표준편차를 표 1에 정리하여 보였다. 표 1의 값들은 0에 가까운 값임을 확인할 수 있다. Sopt 위상의 표준편차는 상대적으로 큰 값이 계산되었는데, 이는 Sopt의 위상이 다른 값들에 비해 상대적으로 큰 결과 값을 갖기 때문이다. 그러나 Sopt의 위상이 주파수에 따라 100° 이상 변하기 때문에 최대표준편차 3.5°는 충분히 작은 값이라고 판단된다.
| NFmin[dB] | Rn[Ω] | Mag(Sopt) | Phase(Sopt)[deg] |
| 0.02 | 0.3 | 0.007 | 3.5 |
측정을 통해 결정된 MGA-72543의 잡음 파라미터 결과는 데이터시트의 결과와 경향은 거의 유사하지만, 전체적으로 크기가 조금 작은 결과를 보였다. 크기에서 오차가 발생하는 것은 앞서 S-파라미터에서 오차가 발생하는 것과 동일하다. 즉, 데이터시트의 결과는 바이어스-티의 잡음영향이 포함된 결과이기 때문에 측정된 결과보다 조금 더 큰 값을 갖는 것으로 판단된다.
Ⅴ. 결 론
본 논문에서는 온-웨이퍼형 DUT 측정을 위한 입력 터미네이션의 정의방법을 제안하였고, 이 제안된 방법으로 새롭게 정의된 입력 터미네이션과 잡음전력비를 이용한 NWCM 측정방법을 이용, 온-웨이퍼형 DUT의 NWCM을 측정하였다. 온-웨이퍼형 DUT의 측정을 위한 입력 터미네이션을 정의하기 위해서 바이어스-티와 프로브 그리고 선로가 결합된 어댑터의 2-포트 S-파라미터 측정방법을 보였고, 이 측정된 S-파라미터를 이용한 온-웨이퍼형 DUT 측정용 입력 터미네이션을 정의하는 방법을 보였다. 그리고 온-웨이퍼형 DUT를 측정하기 위해서, 기존의 측정구성에 웨이퍼 프로브와 바이어스-티를 추가하여, 웨이퍼 측정이 가능한 측정구성을 보였다. 제안된 방법을 통해, 칩 소자의 NWCM을 측정하였고, 측정된 NWCM을 변환하여 칩 소자의 잡음 파라미터 결과를 얻었다. 칩 소자의 잡음 파라미터 결과는 칩 소자의 데이터시트 결과와 유사한 결과를 보였으며, 반복 측정을 통해 측정된 결과가 신뢰할 수 있는 결과임을 보였다.